最近,國產 氟化氬光刻機 的訊息在網路上掀起了熱議,許多網友紛紛高呼國產光刻機的「大突破」,尤其在看到「套刻≤8nm」時,甚至有人誤認為這是8nm的光刻機。但事實真的如此嗎?
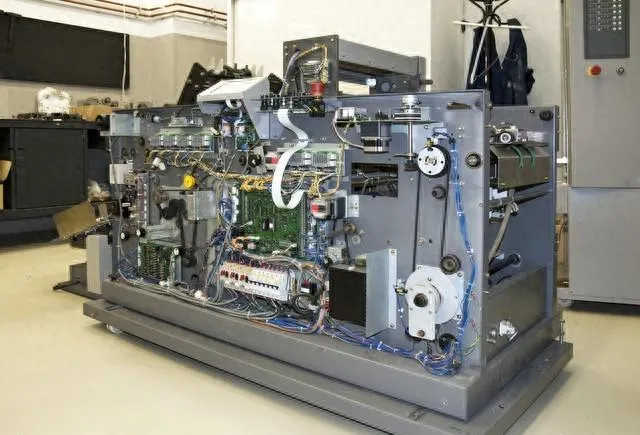
實際上,雖然國產光刻機確實取得了一定進展,但距離真正的技術突破還有很長的路要走。
官方披露
其實早在今年6月20日,工信部釋出了【首台(套)重大技術裝備推廣套用指導目錄(2024年版)】,其中列出了兩款光刻機——氟化氪光刻機(KrF)和氟化氬光刻機(ArF)。氟化氪光刻機采用248nm的光源,分辨率為≤110nm,適用於早期工藝制程。而氟化氬光刻機采用193nm光源,即常見的DUV光刻機,不過這款光刻機是幹式DUV光刻機,而非更先進的浸沒式DUV光刻機(ArFi)。

9月9日,首台(套)重大技術裝備推廣套用指導目錄(2024年版)
根據工信部披露的資訊,這款國產DUV光刻機的分辨率為≤65nm,套刻精度為≤8nm。雖然較之前的國產光刻機有所提升,但並未達到能夠生產28nm甚至更先進制程的水平。而這正是許多網友誤解的地方——將套刻精度誤認為是光刻機制造制程節點的能力。
什麽是套刻精度與分辨率的差異?
套刻精度與光刻機的制造制程並非一回事。套刻精度是指光刻機在多層芯片制造過程中,對每一層光刻圖案進行精準對齊的能力。
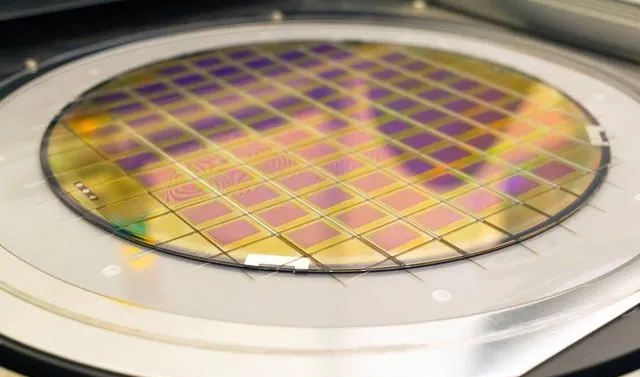
而光刻機的分辨率則決定了芯片工藝制程的節點。在當前披露的國產光刻機中,雖然其套刻精度達到≤8nm,但分辨率只有65nm,也就是說,這款光刻機只能制造65nm或更接近的工藝制程芯片,距離8nm、7nm芯片的制造還相差甚遠。
由此可見, 華為 的 新麒麟芯片 不太可能來自這台裝置所制造的。
65nm光刻機能達到什麽水平?
有網友提出,既然這款光刻機的套刻精度可以達到8nm,是否可以透過多重曝光技術實作更先進的制程?從理論上看,采用多重曝光確實可以提升工藝制程的節點,但前提是套刻精度必須足夠高。而當前的國產光刻機在這方面仍有不少限制。

光刻機的分辨率決定了單次曝光下能夠達到的工藝制程水平。65nm分辨率意味著這款國產光刻機能夠制造65nm左右的芯片,而透過多重曝光可能可以達到更低的工藝制程。但現實問題是,隨著每次曝光,誤差會逐漸放大,這就需要更高的套刻精度來進行糾正。而國產光刻機的套刻精度雖然達到≤8nm,但在多層曝光下,這一精度將不足以支持更先進的工藝制程。
和ASML光刻機的對比:我們和人家的差距仍然明顯
ASML在2015年推出的TWINSCAN XT:1460K光刻機分辨率為≤65nm,套刻精度則為<5nm。這意味著,雖然兩者的分辨率相同,但國產光刻機的套刻精度較差,直接影響了芯片的制造良率。
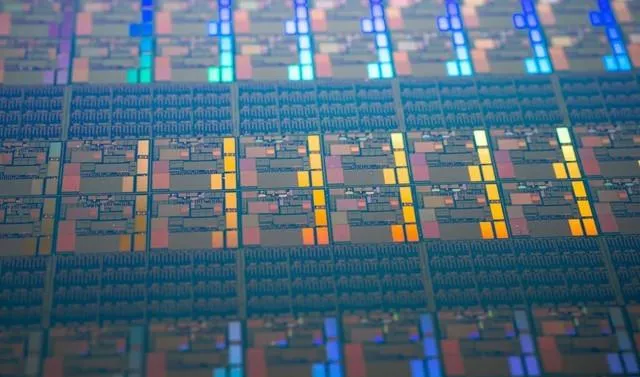
事實上,ASML早在2006年就推出了XT:1450光刻機,其分辨率為57nm,套刻精度為7nm,這已經比當前國產光刻機的效能更好。換句話說,國產光刻機的技術水平實際上還停留在ASML大約18年前的水平。
多重曝光技術的局限:是國產光刻機的瓶頸嗎?
盡管65nm分辨率的光刻機透過多重曝光有可能實作更先進的制程,但這對套刻精度的要求極高。根據光刻機專家的分析,單次曝光的芯片制造需要的套刻精度為1/4至1/5的線寬。也就是說,55nm線寬的芯片需要至少11nm的套刻精度。然而,國產光刻機的套刻精度雖然為≤8nm,但在實際晶圓加工過程中,誤差會進一步放大,實際精度可能會降至11-12nm。因此,國產光刻機在單次曝光情況下最多只能做到55nm-65nm的制程。

而如果要透過多重曝光實作更低的制程,如雙重曝光或四重曝光,那麽所需的套刻精度將進一步提升。根據計算,雙重曝光至少需要5.5nm的套刻精度,而四重曝光則要求2.75nm的精度。顯然,國產光刻機的8nm套刻精度還無法滿足這一要求。

28nm制程為何仍然難以實作?
光刻技術的突破不僅僅依賴於光刻機本身,還包括整個光刻工藝、材料以及相關配套裝置的共同進步。盡管國產光刻機的分辨率有所提高,但在制造28nm制程芯片方面,仍然面臨多重挑戰。以ASML的NXT:1970和NXT:1980為例,雖然其分辨率為38nm,但其套刻精度分別為<3.5nm和<2.5nm,這使得其能夠透過多重曝光實作7nm甚至更先進制程的制造。
更重要的是,美國和荷蘭對先進光刻機的出口限制,已經將NXT:1980及以上的光刻機列入禁售名單。這意味著國產廠商短期內無法獲得先進的浸沒式DUV光刻機,而國內目前仍以幹式DUV為主。
國產光刻機的未來樂觀嗎?
盡管國產光刻機目前仍有較大差距,但也不應忽視其中的進步。65nm的分辨率相比之前的90nm已經是一大提升,顯示出國產光刻機廠商在技術上的積累和努力。然而,與國際領先水平的差距仍然巨大,這一現實要求我們更加理性和清醒,避免盲目樂觀。
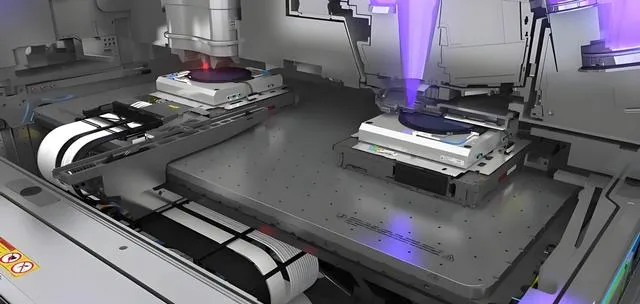
國產光刻機要想從幹式DUV轉向更先進的浸沒式DUV,還需要攻克諸多技術難題。歷史上,ASML正是透過浸沒式DUV打敗了佳能和尼康,成為全球光刻機市場的霸主。如今,國產廠商面臨著類似的挑戰,需要在技術創新和市場競爭中尋找到自己的突破口。
技術突破仍舊需要時間
國產光刻機的進步無疑值得欣喜,但現階段我們必須保持清醒的認識。盡管這款65nm分辨率的光刻機在一定程度上提高了國產光刻機的水平,但其距離真正的大突破還有相當長的距離。盲目樂觀不僅無法幫助我們縮小差距,反而可能導致不切實際的期望。技術突破需要積累和沈澱,唯有腳踏實地,持續創新,才能在未來實作真正的超越。
國產光刻機廠商在技術上面臨的挑戰不僅僅是分辨率和套刻精度,還包括整個生態系的建設和最佳化。在未來的技術競爭中,國產光刻機能否找到自己的突破口,將決定中國芯片制造業的未來。我們期待著那一天的到來,但也清楚地知道,真正的技術突破需要時間和耐心。
文:姜子牙不疼
截圖連結:
工業和資訊化部關於印發【首台(套)重大技術裝備推廣套用指導目錄(2024年版)】的通知











