陶瓷與金屬的連線件廣泛套用於半導體封裝、IGBT模組、新能源汽車和電子電氣等領域。
因陶瓷材料的種類不同,選擇的金屬封接方式也有所差異。目前 , 國內常見的陶瓷基板材料有Al2O3、AlN 和Si3N4,三種基板的重要效能參數如下:

Al2O3、AlN 和 Si3N4 陶瓷基板效能參數
對於Al2O3陶瓷基板主要采用直接覆銅工藝,AlN陶瓷基板可采用DBC或AMB工藝,Si3N4 陶瓷基板在生產中較為廣泛使用的是 AMB工藝。DBC工藝與AMB工藝參數對比如下:

陶瓷與金屬封接,最大難點是陶瓷和金屬的熱膨脹系數相差較大,使得連線完成後的封接界面處會產生較大殘余應力,這不僅會降低接頭強度,也會影響金屬對陶瓷表面的潤濕效果。
幾十年來,國內外先後在陶瓷與金屬的連線工藝上做了許多探索。本文,將主要介紹目前國內外主要采用,且具代表性的幾種陶瓷與金屬的連線方法。

燒結金屬粉末法.
1
燒結金屬粉末法是指在特定的溫度和氣氛中,先將陶瓷表面進行金屬化處理使得瓷件帶有金內容質,再用熔點比母材低的釬料將金屬化後的瓷件與金屬進行連線的一種方法。
其核心思路是,當瓷件表面完成了金屬化處理後,陶瓷與金屬的封接就可以轉變為金屬與金屬的封接,從而大幅降低工藝難度。
在燒結金屬粉末法工藝中,最大的問題是釬料無法潤濕陶瓷表面,從而嚴重阻礙了後續的金屬與陶瓷的封接過程。近幾十年來,科學家們嘗試了各種探討和實驗,總結出了預金屬化采取活化Mo-Mn 法、二次金屬化采取鍍 Ni 處理、釬焊工藝中的釬料采用 Ag72Cu28釬料,在 800 ℃左右溫度 下並施加一定的壓力,於真空或氫氣氣氛中即可 實作焊接。
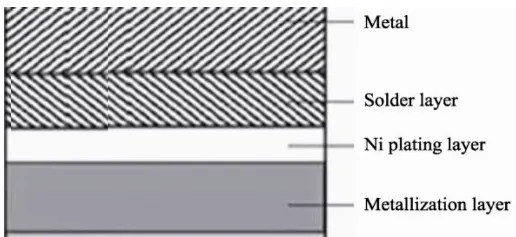
燒結金屬粉末法封接示意圖
目前,氧化鋁陶瓷是國內外陶瓷與金屬封接中使用最為成熟的一種陶瓷材料,因其具有優異的熱、電和機械效能,制造成本也較為低廉。Al2O3 根據主要成分的占比可分為90瓷、95瓷和99瓷等。氧化鋁陶瓷與金屬的封接中較多采用的是 95 瓷 陶瓷材料。
陶瓷基板直接覆銅法(DBC).
2
陶瓷基板直接覆銅法(DBC)最早出現在20世紀70年代,是基於Al2O3 陶瓷基板的一種金屬化技術,具體過程是將其與無氧銅置於高溫和一定的氧分壓條件下,使Cu表面氧化生成一層Cu2O共晶液相薄層,潤濕Al2O3 陶瓷和Cu,當加熱溫度高於共晶溫度且低於Cu熔化溫度時,液相中Cu2O與Al2O3發生化學反應,在銅與陶瓷之間形成一層很薄的過渡層,實作金屬與陶瓷的連線。

Al2O3陶瓷基板DBC工藝流程圖
目前,覆銅陶瓷基板能像PCB路線板一樣刻蝕出各種圖形,是率模組封裝中連線芯片和散熱襯底的關鍵材料,目前,已廣泛用於混合動力模組,雷射二極體和聚焦型光伏封裝,在高頻套用方面也體現出了巨大的套用價值。
AlN陶瓷基板敷銅是基於DBC工藝發展起來的。氮化鋁陶瓷基板覆銅具有氧化鋁陶瓷基板覆 銅約 6-8 倍的高導熱性,其介電常數低、具有優良 的電絕緣性且熱膨脹率與矽相近,其廣泛套用在 新型的半導體封裝材料。
在工藝過程中,由於AlN陶瓷與Cu的潤濕性極差,氮化鋁陶瓷基板和氧化鋁表面層熱膨脹性不匹配導致兩者之間產生了張應力,同時氧化鋁層與所封接的銅之間的熱膨脹系數差異更大,Cu必將對氧化層產生壓應力。兩種應力相互補償抵消,反而使得氧化層與瓷體的強度增大, 對鍵合強度起到積極作用。
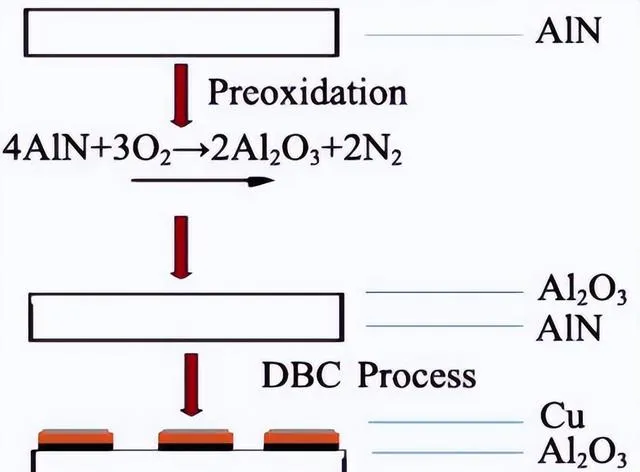
AlN陶瓷基板陶瓷基板DBC工藝流程圖
活性金屬釬焊法 (AMB).
3
活性金屬釬焊法(Active Metal Brazing, AMB)比燒結金屬粉末法發展約晚10年,它是在釬料中加入活性元素,透過化學反應在陶瓷表面形成反應層,以此提高釬料在陶瓷表面的潤濕性,從而進行陶瓷與金屬間的化學接合。因其整個工藝過程可在一次升溫中完成,操作簡單、時間周期短、封接效能好並且對陶瓷的適用範圍廣,目前已經成為了電子器件中常用的一種方法。
AMB工藝中主要涉及了活性層的覆蓋、釬料層的覆蓋及封接燒結過程。具體工藝流程如下圖所示:
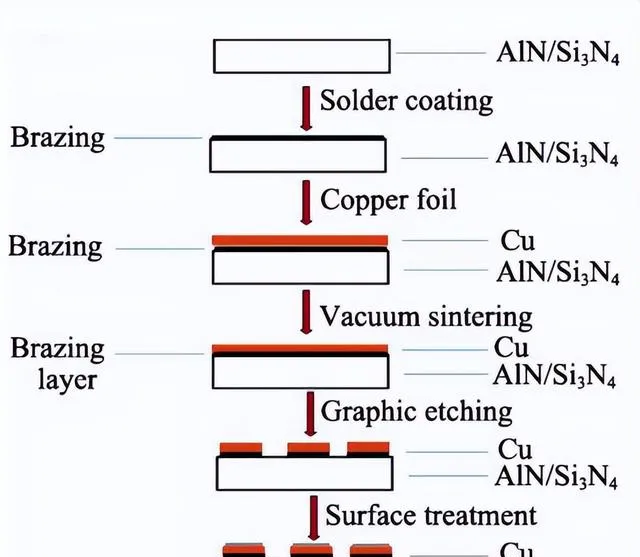
Si3N4/AlN基板AMB工藝流程圖
目前,Si3N4 和 AlN 等非氧化物陶瓷基板覆銅在生產中廣泛采用 AMB 工藝。其中,氮化矽具有優異的機械效能(高彎曲強度, 高斷裂韌性)以及熱膨脹系數小、摩擦系數小等諸 多優異效能,是綜合效能最好的結構陶瓷材料。氮化鋁具有高熱導率使其成為理想的基板材料和高可靠性的電力電子模組,是近年來國內外陶瓷基板領域重點研究方向之一。
機械連線.
4
機械連線是一種古老的連線方法,常見的有栓接和熱套等。栓接方法簡單且接頭可進行拆卸, 但是其接頭處無氣密性等,無法很好地套用在精密器件中。熱套則是利用陶瓷與金屬的熱膨脹效能的差異形成的組合,即金屬加熱時較大膨脹,冷卻時收縮,金屬的收縮大於陶瓷。

陶瓷與金屬熱套連結的陶瓷缸套
固相擴散連線.
5
固相擴散連線是將材料置於惰性氣氛或真空環境中,透過高溫和壓力的作用,首先使待接面局部發生塑性變形,促使氧化膜破碎分解,促使原子擴散,再透過原子間的擴散或化學反應形成反應層,從而實作連線。
固相擴散連線的優點是接頭強度高,彈性變形量小,對材料種類沒有限制。但其所需要的連線溫度較高,連線時間也相對較長;並且因其通常是在真空下進行,這就需要借助昂貴的真空裝置來完成工藝,因此,導致了工藝成本高、試件尺寸易受限制。
目前,國內在套用HIP擴散焊接方面取得許多進步,其產品套用在航空 航天、電力電子和新能源等各大領域。
自蔓延連線.
6
自 蔓 延 高 溫 合 成 (Self-propagating Hightemperature Synthesis Joining, SHS)是一種新材料合成工藝,其透過反應所放出的 熱為高溫熱源,以 SHS 產物為焊料,實作材料的連線。此方法能耗低、生產效率高, 但由於反應速度極快,焊料燃燒時間不易控制, 導致界面反應控制困難。
雖然陶瓷與金屬的連線方法較多,但是每種方法都有其自身的優點和局限性,甚至有些方法還處於實驗研究階段,一時還難以大規模商用。
目前,陶瓷與金屬 連線較為廣泛采用的方法主要為釬焊連線技術, 其產品效能穩定、工藝可靠性高、生產成本合理。
隨著電子元器件的功率及封裝整合度的不斷增大,對封裝散熱基板綜合效能的要求也隨之提高,高效能的陶瓷基板覆金屬箔必將是今後的一個重點研究方向。











