
行動通訊是現代人生活中必備的工具,其中通訊系統中濾波電路決定了通訊品質。(資料來源:閎康科技,經科技新報編修為上下兩篇,此篇為下篇。)
AlN濾波器因具備可高頻操作、對溫度穩定性高及與CMOS制程相匹配等優點,可實作濾波芯片積體化,滿足行動通訊短小輕薄的要求,故為制作濾波芯片的主力。面對目前的5G通訊時代,行動通訊元件對於濾波器的要求更高,不僅要滿足高頻操作,擁有更大的頻寬,且需具有更低訊號損漏的Q值。
近年來,有學者發現在AlN中摻入Sc原子所產生的應力,能讓ScxAl1-xN產生較AlN更好的壓電表現 (資料來源: 科儀新知第233期: ScxAl1-xN壓電共振器實作5G毫米波行動通訊積體化)。對於如何檢測矽基板上是否增長出高品質的AlScN薄膜成為了通訊元件廠所重視的議題。
針對鍍膜品質的監控,可透過XRD中的Rocking Curve方式進行把關,當晶體結構排列規則整齊時,在定住特定的繞射峰進行ω軸擺蕩,繞射強度會因不符合布拉格定律的關系,一旦改變ω角度,就會大幅降低強度;反之,在晶格隨意排列狀況下,因各方向都有特定繞射峰的分量,因此隨著ω軸擺蕩,該繞射峰強度是緩慢降低,如圖12。
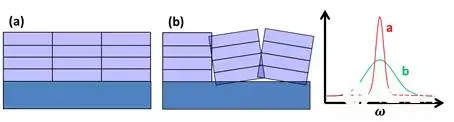
圖12. 鍍膜晶格堆疊排列對於Rocking Curve的影響。
下圖13顯示兩種堆疊結構的AlScN都呈現良好的 (002) 優選方向,但從Rocking Curve的分析結果,明顯可以觀察到左圖的半高寬較窄,說明該堆疊結構對於表面的AlScN排列較有幫助。
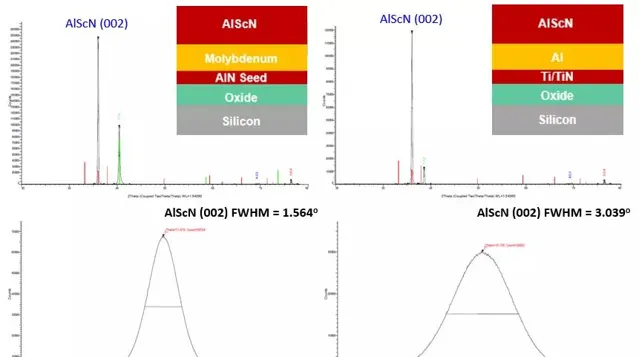
圖13. (上) 鍍膜的XRD分析結果,AlScN都呈現良好的 (002) 優選方向;(下) 針對AlScN (002)進行Rocking Curve的分析結果,左圖的半高寬較窄,說明該堆疊結構對於表面的AlScN的排列較有幫助。
在Si MOSFET元件制程微縮的演進中,如何提升通道中電子與電洞的移功率(mobility)成為提高元件效能的關鍵課題。其中,應變工程(Strained Engineering,Strained-Si)被認為是提升Si納米元件效能最有效的方法之一。
在應變工程中,SiGe作為PMOS材料具有顯著的優勢,因其電洞遷移率高於Si,並展現出更優異的負偏壓溫度不穩定性(NBTI)可靠性。此外,SiGe與Si基板的晶格匹配度更佳,使其成為提升元件效能的理想選擇。
由於Si與SiGe的晶體結構相同,晶格間距接近,若透過一般繞射的分析方式,兩者的繞射峰位置幾乎重疊。此時需要搭載單晶配件提高XRD的角度分辨率及入射光的準直性,以使分析結果對晶格變化具更高的靈敏度。圖14透過HRXRD分析,得到SiGe繞射峰,透過軟件擬合該繞射峰的相對位置,即可得到各層SiGe的比例關系,而繞射峰周圍的衛星峰的周期性震蕩,則可以得到各層次相對應的厚度。

圖14. 多層SiGe與Si磊晶的HRXRD分析結果,透過軟件擬合該繞射峰的相對位置可得到各層SiGe的比例關系,而繞射峰周圍的衛星峰的周期性震蕩則可以得到各層次相對應的厚度。
SiGe磊晶增長過程中,為了維持Si與SiGe界面原子鍵結完整與連續性,SiGe磊晶層的晶格面間距必須形變去迎合Si基板的間距,因此產生了晶格匹配程度的問題。其中在矽與SiGe晶層中晶格不匹配的情況又可以分成三類: 完全松弛、部份松弛、完全形變,而透過倒空間觀察繞射峰分布的改變與其所對應的方向可以從中獲得多種磊晶結構特性。
然而,不論磊晶增長的是形變層或松弛層,松弛程度的測量都相當重要,而唯有利用倒易空間(RSM) 圖譜分析技術才能精確地鑒定出異質磊晶薄膜的松弛程度 (來源: 科儀新知第二十九卷第一期96.8_ X光倒易空間圖譜技術分析矽鍺異質磊晶材料的應變)。圖15顯示在Si基板上增長具有濃度梯度的SiGe緩沖層上(該緩沖層Ge的濃度是由下往上增加),可長出具高晶體質素的Si0.5 Ge0.5高應變層,該臨界厚度約為50 nm,當大於其臨界厚度 -20 nm後,表面的Si0.5 Ge0.5層會開始出現應變釋放。

圖15. RSM分析結果顯示表面SiGe應變層臨界厚度約50nm,隨著表面SiGe厚度增加應變釋放的效應增加。(資料來源: J Mater Sci: Mater Electron 30, 14130–14135 (2019). A novel three-layer graded SiGe strain relaxed buffer for the high crystal quality and strained Si0.5Ge0.5 layer epitaxial grown)
RSM圖譜除了從倒空間觀察繞射峰分布的訊息外,也可以透過軟件分析,從RSM的圖譜取得各層SiGe成分比例及各層與Si基板間的松弛程度,如圖16。
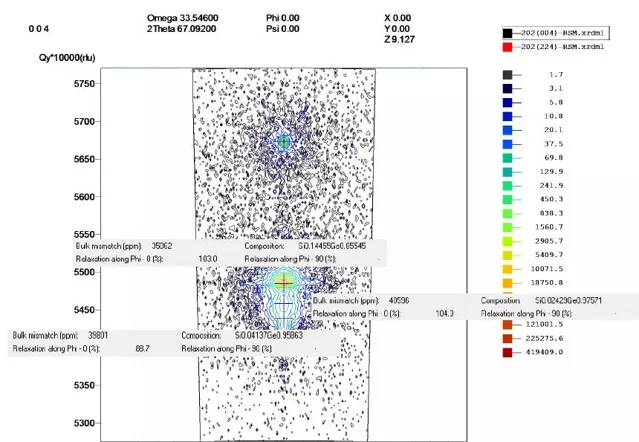
圖16. RSM結果顯示越接近Si基板的SiGe層,晶格mismatch越小;越遠離Si基板的SiGe層晶格mismatch越大,因此有SiGe有松弛的現象發生,即應力釋放。(資料來源: 台灣半導體研究中心)
材料復雜的堆疊,並經過多次不同的制程,因材料的膜厚或是物性差異,如熱膨脹系數、密度、晶格間距等,容易在層與層之間產生內應力。後續再經過多道制程,如CMP研磨,極可能在局部應力集中的區域,發生剝離或破裂的現象導致產品失效。
當薄膜發生擠壓或拉伸的狀況,材料的晶格間距會發生改變,因此可借由XRD或是GIXRD測量繞射峰角度位移量 (Δ2θ) 得到晶格變化量 (圖17)。並根據固體彈性理論計算 (〖sin〗^2 ψ法或是 〖cos〗^2 αsin2ψ法),即可求出薄膜殘留應變,再帶入材料普松比 (Poisson's ratio) 與楊氏系數 (Young's modulus) 即可知道薄膜的殘留應力 (圖18)。

圖17. 受擠壓或拉伸的狀況下,晶格間距在各方向改變的示意圖。
圖18為Cu薄膜透過GIXRD分析結果,隨著φ角的改變,可以發現繞射峰位置逐漸往低角度移動,意味著晶格間距改變,表示薄膜內有殘留應力的存在,導致相同的晶格面在各方向有不同的變化狀況。
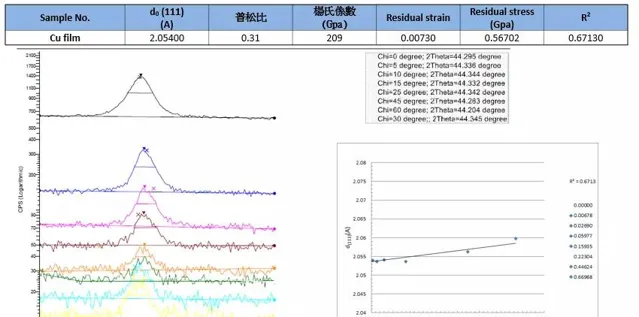
圖18. 多晶Cu鍍膜的殘留應力分析結果,透過低掠角繞射分析方式取得Δ2θ,經彈性理論計算出該薄膜的殘留應力為0.567 GPa張應力。
電子顯微鏡與X光繞射為常見的材料微結構分析的兩大工具,電子顯微鏡可以觀察到特定區域的細微結構,但需要樣品制備且須在真空測試環境下進行;XRD分析則可在大氣環境下,無需特別制備樣品,分析上更方便。此外,XRD為非破壞性分析方式,可在樣品環境下進行臨場分析,加上大區域分析的平均結果,可獲得材料整體特性。
XRD技術可以進行材料的結晶相、晶向、結晶性、晶粒尺寸、鍍膜的優選方位、多晶薄膜的殘留應力分析;若搭配高分辨率配件可進行鍍膜/磊晶品質分析、異質磊晶薄膜成分比例、厚度、晶格匹配度或是松弛分析;若透過全反射技術可分析多層薄膜厚度、表面/界面粗糙度、材料密度等。總的以上的案例,XRD的套用層面非常廣,對於先進制程上或是材料的研發,都能提供相當的技術尋求各式分析需求。
(首圖來源:Shutterstock;資料來源:閎康科技)











