顯示驅動芯片是顯示面板成像系統的重要組成部份之一,目前常見的顯示驅動芯片包括LCD驅動芯片和OLED驅動芯片。LCD驅動芯片透過接收控制芯片輸出的指令,決定施加何種程度的電壓到每個像素的晶體管,從而改變液晶分子排列/扭轉程度,由每個像素的透光率高低實作色彩變化,進而構成顯示畫面。OLED驅動芯片透過向OLED單元背後的薄膜晶體管發送指令,控制OLED子像素的亮度進而發出不同顏色的光。公司目前所封裝測試的顯示驅動芯片被廣泛套用於智能電話、智能穿戴、高畫質電視、筆記電腦、平板電腦等顯示面板中。
顯示驅動領域全制程封裝測試涉及的服務,按照具體工藝制程包括金凸塊制造(GoldBumping)、晶圓測試(CP)、玻璃覆晶封裝(COG)和薄膜覆晶封裝(COF),具體情況如下:


工藝流程
顯示驅動芯片的封裝成型需要經過多道工序的協同配合。首先,對客供晶圓進行微觀檢測,觀察其是否存在產品缺陷;對於檢驗合格的晶圓,在其表面制作金凸塊作為芯片接合的基礎;其後,對晶圓上的每個晶粒用探針進行接觸,測試其電氣特性,對不合格的晶粒進行墨點標識;接著,將晶圓研磨至客戶需要的厚度再進行切割,僅將合格的芯片挑揀出來;最後,客戶要求在玻璃基板上進行接合的則在完成切割、挑揀後包裝出庫(COG),由面板或模組廠商負責芯片與玻璃基板的接合;客戶要求在卷帶上進行接合的則需要先將芯片內引腳與卷帶接合並塗膠烘烤牢固,進行芯片成品測試後再包裝出庫(COF)。在整道生產流程中還包含多次的人工目檢以及光學自動檢測,以保障產品的質素。

1、金凸塊制造 (GoldBumping)金凸塊制造是晶圓入料檢查完成後的首道工序,制造出的金凸塊是後續引腳接合的基礎,制作過程復雜,其中主要步驟的工藝流程圖如下:
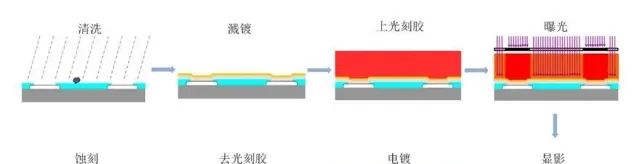
具體過程如下:
(1)清洗: 用去離子水清洗入料檢驗合格的晶圓,去除表面雜質。
(2)濺鍍: 用高速離子對金屬靶材進行轟擊,將鈦鎢金靶材濺射至矽片表面,形成凸塊底部金屬層。
(3)上光刻膠、曝光、顯影: 塗布光刻膠,並透過光掩膜板對塗膠的矽片進行曝光,使光刻膠發生化學反應,再將其浸入顯影液中則只有部份會溶解,從而得以在光刻膠上對凸塊的位置開窗。
(4)電鍍: 將晶圓浸入電鍍液中,通電後電鍍液中的金屬離子,在電位差的作用下將移動到開窗部位形成金凸塊。
(5)去光刻膠、蝕刻: 去除光刻膠,並透過蝕刻精準去除金凸塊周圍的金層和鈦鎢層,金凸塊則制作完成。
(6)良品測試: 對晶圓表面金凸塊的各項測量規格如高度、長寬尺寸、硬度、表面粗糙度、切應力等進行良品測試後則可進入晶圓測試制程。
2、晶圓測試(CP)
晶圓測試是指用探針與晶圓上的每個晶粒接觸進行電氣連線以檢測其電氣特性,對於檢測不合格的晶粒用點墨進行標識,透過點墨標識一方面可以直接計算出晶圓的良率,另一方面可以減少後續工序的工作量,提高封裝的效率,有效降低整體封裝的成本。該工序主要透過測試器材與探針台協同完成。
3、玻璃覆晶封裝(COG)
玻璃覆晶封裝是指將芯片上的金凸塊與玻璃基板進行接合的先進封裝技術,由封裝測試廠商將芯片研磨、切割成型後,由面板或模組廠商將芯片與玻璃基板相結合。公司的玻璃覆晶封裝制程主要包括研磨、切割和挑揀等環節,主要步驟的工藝流程圖如下:
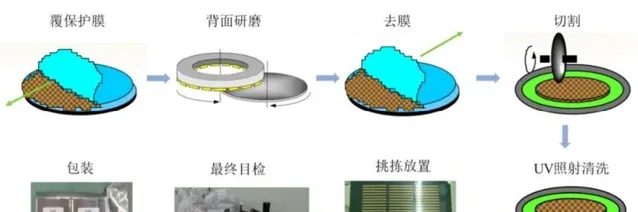
具體過程如下:
(1)覆保護膜: 將膠膜覆於晶圓正面,膠膜可以在研磨過程中保護晶圓表面免受損傷與汙染。
(2)背面研磨: 將晶圓背面朝上進行研磨,研磨至客戶要求的厚度。
(3)去膜、切割: 去掉保護膠膜後,將晶圓箍於鐵框內,用鉆石刀片將晶圓切割成相應規格的芯片,切割後再次觀測其是否存在碎裂、裂痕、刮傷、金屬翹起等缺陷。
(4)UV照射清洗: UV照射清除表面有機汙染物,減弱膠層強度以便後續挑揀。
(5)挑揀放置、最終目檢: 將切割好的清潔的芯片挑揀放置於盛載盤上,最終透過顯微鏡進一步目檢。
4、薄膜覆晶封裝(COF)
薄膜覆晶封裝與玻璃覆晶封裝的工藝差別在於與芯片直接接合的基板不同,以及薄膜覆晶封裝需進行芯片成品測試。玻璃覆晶封裝是將芯片引腳直接與玻璃基板接合,故只需切割成型,後續引腳接合由面板或模組廠商負責,而薄膜覆晶封裝的軟性電路基板。

薄膜覆晶封裝主要步驟的工藝流程圖如下
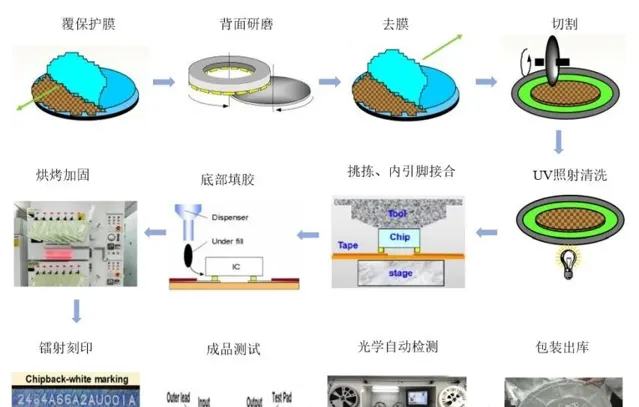
具體過程如下:
(1)覆保護膜: 將膠膜覆於晶圓正面,膠膜可以在研磨過程中保護晶圓表面免受損傷與汙染。
(2)背面研磨: 將晶圓背面朝上進行研磨,研磨至客戶要求的厚度。
(3)去膜、切割: 去掉保護膠膜後,將晶圓箍於鐵框內,用鉆石刀片將晶圓切割成相應規格的芯片,切割後再次觀測其是否存在碎裂、裂痕、刮傷、金屬翹起等缺陷。
(4)UV照射清洗: UV照射清除表面有機汙染物,減弱膠層強度以便後續挑揀。
(5)挑揀、內引腳接合: 將切割好的清潔的芯片挑揀出來把芯片上的金凸塊與卷帶的內引腳進行接合。
(6)底部填膠、烘烤加固: 對準芯片周邊底部進行填膠粘合,再置於烘烤器材中烘烤牢固。
(7)鐳射刻印: 公司會對加工好的芯片鐳射刻印編號,便於後續追溯到產品。
(8)成品測試、光學自動檢測及包裝出庫: 利用檢測器材進行芯片成品測試,檢驗其電氣性、微觀結構等,以及外觀檢測其是否存在缺陷,檢驗合格則可整卷包裝出庫。











