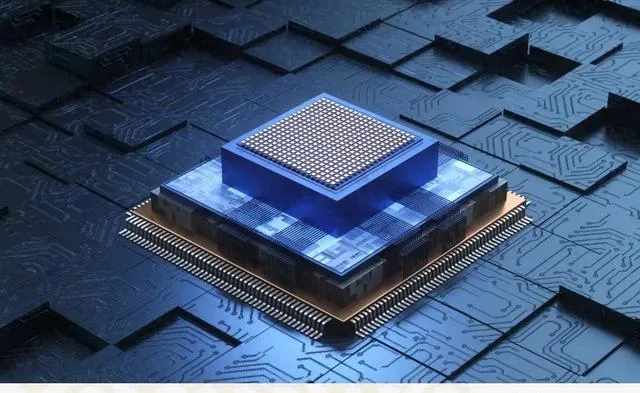
本文由半導體產業縱橫(ID:ICVIEWS)綜合
SK 海力士突破 HBM 堆疊層數限制,MR-MUF 和混合鍵合封裝兩手抓。

近日,SK 海力士封裝研發副社長李康旭(Kangwook Lee)於 9 月 3 日出席「2024 年異構整合全球峰會」,發表了名為「面向人工智能時代的 HBM 和先進封裝技術」的演講。
HBM 是克服 「儲存墻」(Memory Walls)的最佳化解決方案,透過 I/O 並列化能力,使 HBM 成為人工智能系統中用於訓練和推斷的最高規格動態隨機存取記憶體(DRAM)。
根據套用產品不同,使用的 HBM 數量也不同。隨著 HBM 世代發展,在訓練和推理人工智能伺服器中搭載 HBM 的平均數量也會增加,如近期訓練伺服器需要 8 個 HBM3E、推理需要 4 - 5 個,長遠估算可能分別需要 12 個和 8 個 HBM4/HBM4E 記憶體。
李康旭表示,SK 海力士計劃 2025 年推出 12 層 HBM4 產品,透過自家研發的封裝技術,在 HBM 產品的能效和散熱效能方面具有優秀的產品競爭力。
有趣的是,SK 海力士到 HBM3E 仍是以動態隨機存取記憶體基礎裸片(Base Die),采用 2.5D 系統級封裝,到 HBM4 考慮將動態隨機存取記憶體基礎裸片改成邏輯基礎裸片(Logic Base Die),使效能和能效獲得提升。此外,到了 HBM5 架構可能出現改變,SK 海力士目前正在評估包括 2.5D 和 3D 系統級封裝(SiP)在內的各種方案。
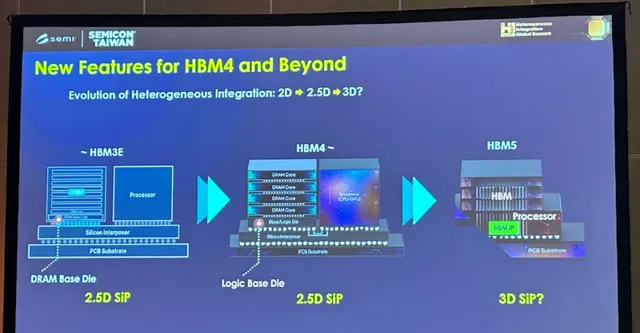
SK 海力士技術朝兩個方向進行:封裝 MR-MUF 和混合鍵合(Hybrid Bonding)
MR-MUF技術由SK海力士多個團隊共同開發,該技術能夠同時對HBM產品中所有的垂直堆疊芯片進行加熱和互聯,比堆疊芯片後填充薄膜材料的TC-NCF技術更高效。此外,與TC-NCF技術相比,MR-MUF技術可將有效散熱的熱虛設凸塊數量增加四倍。
MR-MUF技術另一個重要特性是采用了一種名為環氧樹脂模塑膠(EMC, Epoxy Molding Compound)的保護材料,用於填充芯片間的空隙。EMC是一種熱固性聚合物,具有卓越的機械性、電氣絕緣性及耐熱性,能夠滿足對高環境可靠性和芯片翹曲控制的需求。由於套用了MR-MUF技術,HBM2E的散熱效能比上一代HBM2提高了36%。
從開發HBM2E開始,MR-MUF技術及隨後推出的先進MR-MUF技術的套用,使SK海力士能夠生產出業界最高標準的HBM產品。時至2024年,SK海力士已成為首家量產HBM3E的公司,這是最新一代、擁有全球最高標準效能的HBM產品。在套用先進的MR-MUF技術後,與上一代8層HBM3相比,HBM3E在散熱效能方面提高了10%,成為人工智能時代炙手可熱的記憶體產品。
SK 海力士的高頻寬記憶體(HBM)產品采用 MR-MUF 封裝技術,具有低壓、低溫鍵合和批次熱處理的優勢,在生產效率和可靠性方面優於熱壓膜非導電膠(TC-NCF)制程。此外,具有高熱導特性的填充空隙材料(Gap-Fill 材料)和高密度金屬凸塊(在垂直堆疊 HBM 動態隨機存取記憶體時起連線電路作用的微小鼓包型材料)的形成,在散熱方面比 TC-NCF 制程有 36% 的效能優勢。
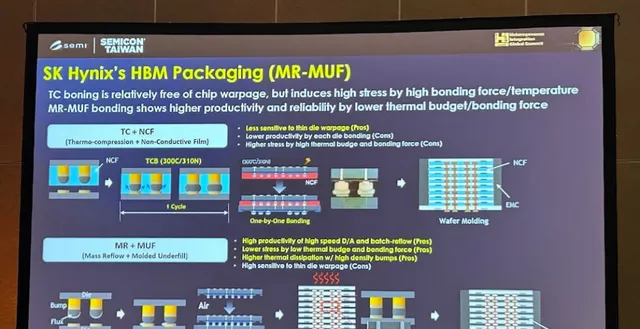
由於堆疊將面臨高度限制,目前 SK 海力士不斷尋找新方法,在有限高度下裝入更多堆疊層數。李康旭指出,公司 8 層 HBM3/HBM3E 使用 MR-MUF 技術;12 層 HBM3/HBM3E 采用先進 MR-MUF 技術;明年下半年準備出貨的 12 層 HBM4 同樣采用先進 MR-MUF 技術;至於 16 層 HBM4/HBM4E 將同步采用先進 MR-MUF 和混合鍵合(Hybrid Bonding)兩種技術,未來堆疊 20 層以上產品(如 HBM5)則將轉向混合鍵合技術發展。
混合鍵合是一種先進的集成電路封裝技術,主要用於實作不同芯片之間的高密度、高效能互聯。這種技術的關鍵特征是透過直接銅對銅的連線方式取代傳統的凸點或焊球(bump)互連,從而能夠在極小的空間內實作超精細間距的堆疊和封裝,達到三維整合的目的。
在混合鍵合工藝中,兩個或多個芯片的金屬層(通常是銅層)被精密對準並直接壓合在一起,形成直接電學接觸。為了保證良好的連線效果,需要在芯片表面進行特殊的處理,例如沈積一層薄且均勻的介電材料(如SiO2或SiCN),並在其上制備出微米甚至納米級別的銅墊和通孔(TSV)。這些銅墊和通孔將芯片內部的電路與外部相連,使得數據傳輸速度更快、功耗更低,同時極大地提升了芯片的整合度。
李康旭指出,SK 海力士正在研發 16 層產品的相關技術,最近確認對 16 層產品可套用先進 MR-MUF 技術的可能性。此外,該公司也強調,從 HBM4E 開始會更強調 「客製化 HBM」,以滿足各種客戶需求,如提升芯片效率。
*聲明:本文系原作者創作。文章內容系其個人觀點,我方轉載僅為分享與討論,不代表我方贊成或認同,如有異議,請聯系後台。











