【1. IC 载板是芯片封装环节关键部件】
FC - BGA载板是连接DIE和PCB信号的载体,它的技术要求很高。
IC载板也叫封装基板,它是能连接并传输裸芯片(DIE)和印刷电路板(PCB)之间信号的一种载体,你可以把它看成是一种比较高端的PCB产品。IC载板主要有保护电路、固定线路以及传导和散发余热这些功能,在封装的过程里它可是关键的部件呢。在低端封装的时候,它的成本能占到40 - 50%,高端封装的时候能占到70 - 80%。在高阶封装这个领域,传统的引线框架已经被IC载板给取代了。
IC载板在技术要求上比PCB更高。IC载板是从HDI(高密互联)技术发展来的,从普通PCB到HDI,再到SLP(类载板),最后到IC载板,加工精度是一步步提高的。IC载板制造的时候,和传统PCB用的减成法不一样,它主要是用SAP(半加成法)、MSAP(改良型半加成法)这些工艺,需要的设备不一样,加工成本也更高,像线宽/线距、板厚、孔径这些指标更精细,对耐热性的要求也更高。
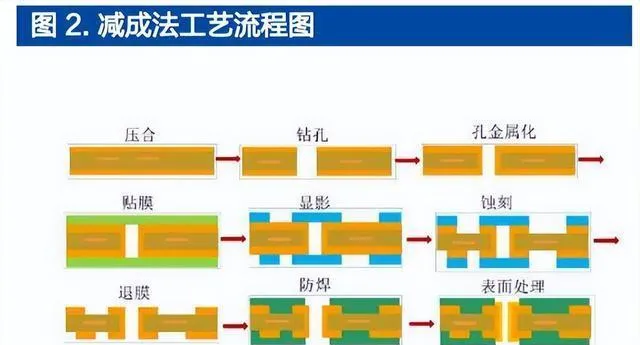
IC载板能够按照封装方式和基材来分类。
IC载板按主流封装形式能分成WB/FCBGA/CSP这四类,其中FC - BGA的技术要求最高。WB/FC是裸芯片和载板的连接形式,WB(Wire Bonding,也就是打线)是用引线把裸芯片和载板连起来,FC(Flip Chip,覆晶)呢,是把裸芯片正面翻过来,用锡球凸块直接连到载板上,这个锡球凸块就相当于芯片和电路板之间电性连接与传输的缓冲界面。FC因为是用锡球代替引线,和WB比起来,它能提高载板信号密度,让芯片性能变好,而且凸点对位校正的时候更方便,良率也能提高,所以FC是更先进的连接方式。
BGA/CSP是载板和PCB之间的连接形式。移动端芯片适合用CSP,PC或者服务器级的高性能处理器适合用BGA。BGA,也就是Ball Grid Array(球栅阵列封装),是在晶片底部按阵列形式排布好多锡球,用锡球阵列来取代传统金属导线架当接脚。CSP,即Chip Scale Package(芯片级封装),能让芯片面积和封装面积之比大于1:1.14,这已经很接近1:1的理想状态了,大概是普通BGA的1/3,可以把它看作是锡球间距和直径更小的BGA。从下游应用来讲,FC - CSP更多用于移动设备的AP、基带芯片,FC - BGA用于PC、服务器级的CPU、GPU等高性能芯片封装。这种基板层数多、面积大、线路密度高、线宽和线距小,而且通孔、盲孔的孔径小,它的加工难度比FC - CSP封装基板要大得多。
IC载板按基材能分成BT/ABF/MIS这三类,日本味之素把高性能处理器载板用的ABF材料给垄断了。IC载板的基板和PCB覆铜板差不多,主要有硬质基板、柔性薄膜基板、共烧陶瓷基板这三大类。不过呢,硬质基板和柔性基板差不多占了整个市场,主要的基材就是BT、ABF、MIS这三种。BT基板是三菱瓦斯研发出来的一种树脂材料,它耐热和电气性能都不错,就把传统陶瓷基板给取代了,热胀冷缩不明显,尺寸很稳定,材质硬,线路粗,主要用在手机MEMS、通信和储存芯片封装上。ABF是日本味之素研发的一种增层薄膜材料,硬度更高,厚度薄,绝缘性也好,适合细线路、高层数、多引脚、高信息传输的IC封装,在高性能CPU、GPU、chipsets这些领域能用得上。ABF的产能都被味之素垄断了,这可是国内载板生产时很关键的卡脖子原材料。MIS是一种新型材料,和传统基板不一样,它有一层或者多层预包封结构,每一层都靠电镀铜来互连,线路更细,电性能更好,体积更小,在功率、模拟IC还有数字货币领域发展得很快。
1.2. 下游应用适配封装工艺交替上升,服务器/存储是未来的推动因素。
IC载板主要用于IC封装,它的规模增长会随着半导体行业规模的增速有一定的周期性波动。2021年的时候,半导体行业整体发展趋势向好,这就使得IC载板的市场规模大幅增长,增长速度达到了近十年的最高值。

回顾历史,IC载板的增长是被下游各类终端应用以及与之适配的封装工艺交替推动的:2005 - 2010年:PC和服务器芯片发展得很快,FC - BGA载板是主要的增长推动因素,当时市场规模增长速度为10.2%,出货量增长速度是20.2%。2010 - 2015年:智能手机流行起来了,移动端芯片的需求大增。FC - CSP封装基板因为尺寸小,符合移动端「轻薄短小」的要求,所以增长得很快,而FC - BGA封装基板的情况则是下滑。由于移动终端市场竞争很激烈,而且尺寸小等原因,载板的单价比较低,所以虽然出货量是增长的,但价值量却下降了,在这个时期,市场规模增速是 - 3.1%,出货量增速是4.3%。2015 - 2020年:PC市场复苏了,服务器的需求也上升了,市场迎来了拐点,FC - BGA和模组载板的增长加快了,载板市场从过剩变成了短缺,这个期间规模增速为8%,出货量增速为6.1%。2020 - 2026年:2021年IC载板市场规模达到了142亿美元,比上一年多了40亿美元,增速为39%,出货量是0.78亿片,增速为13%。FC - BGA载板和新出现的AiP/SiP等模组载板是主要的增长动力,复合增速超过10%,手机市场发展变缓,对FC - CSP载板的需求也就减少了。预计载板市场规模增速为13.2%,出货量增速为7.9%。
从下游的应用方面来说,PC、服务器、消费电子、通信这几个方面加起来占了95%。服务器和存储用到的高性能计算以及存储芯片,它们对载板的需求会是以后最主要的增长动力。在2021年的时候,PC(高性能CPU/GPU,价值42亿美元,占比29%)还是最大的主流应用。手机(SoC/射频,价值36亿美元,占比25%)、服务器/存储(高性能处理器/存储,价值24亿美元,占比17%)、其他消费类(价值21亿美元,占比15%)紧跟在后面。前四大应用总共占了86%的份额,另外通信(有线加无线,价值13亿美元,占比9%)也占了一定的份额。以后呢,预计因为疫情居家而在PC上出现的高增长会降下来,消费电子(手机加上其他的)会恢复平稳,服务器/存储类芯片对载板的需求会成为主要的推动力量,无线通信和汽车也会有比平均水平略高的增长速度。

【2. 需求端:高性能芯片带动 ABF 载板,国产载板有望受益本土产业 链配套需求】
2.1. ABF需求提升靠高性能计算芯片驱动。
北美的云巨头业务韧性很强,CAPEX有望持续增长,从而推动服务器需求上升。从各公司22Q2财报来看,亚马逊AWS营收达197.39亿美元,同比增长33%;谷歌云营收为62.76亿美元,同比增长35.6%;微软云业务营收209.1亿美元,同比增长20%。这三大云巨头的CAPEX也分别增长了8.6%、24.2%、6.5%,整年都有望保持在高位。Synergy Research Group的数据显示,2022年Q2全球企业在云基础设施服务上的支出是547亿美元,同比增长29%。云服务商CAPEX的增长会让服务器出货量不断增加。IDC的数据表明,2022年全球服务器出货量有望达到1420万台,同比增长10%,到2025年将增长到1700万台,复合年增长率为7.3%。

2.2. 华为自研服务器芯片靠Chiplet实现弯道超车,国产载板配套恰逢其时。
华为被制裁「缺芯」,只能卖掉x86服务器业务。2019年5月华为被列入实体清单之后,美国对华为供应链的封锁越来越严。到了2020年9月15日之后,像镁光、三星、海力士、英特尔、高通、索尼、联发科、台积电、中芯国际这些存储、处理器、代工的厂商,都被迫不能给华为供货了。这样一来,华为就没办法从外面采购芯片,自己研发的芯片也不能用先进制程来制造。于是在2021年,华为不得不出售部分消费电子业务(荣耀)和x86服务器业务(超聚变)。

Chiplet封装工艺也许能帮国产半导体企业实现弯道超车。Chiplet呢,平常也叫芯粒或者小芯片。它就是把能满足特定功能的裸片(die),用die - to - die内部互联技术,把好几个模块芯片和底层基础芯片封装在一块,弄成一个系统芯片,这样就达成了一种新的IP复用形式。它能把不同制程的芯片封装到一起,让系统性能达到最优,有不少好处,像提高大芯片的良率,让设计没那么复杂还能降成本,制造的时候成本也能降下来,在摩尔定律慢下来之后,这就被看作是中国半导体企业弯道超车的机会了。

2.3. 国产存储芯片从无到有实现突破,为国产BT载板带来配套空间。
国产存储芯片厂商在从0到1上取得了突破,长存和长鑫有希望在NAND Flash、DRAM市场分到一定份额。存储芯片市场主要份额被美日韩厂商占据着,就DRAM市场而言,韩国的三星和海力士在全球占有72%的份额;在NAND Flash市场,韩国占全球47%的份额,美日厂商把剩下的绝大部分份额瓜分了,我国存储芯片一直被海外厂商制约。为改变这种情况,国产千亿级项目厂商长江存储(主要做NAND Flash)、长鑫存储(主要做DRAM)达成了存储芯片国产化从0到1的突破。长江存储武汉存储器基地一期产能已经稳定量产,2021年的产能是10万片/月,二期在2020年6月开工,达产后总产能会达到30万片/月,预计市场份额能提高到7%,超过英特尔成为世界第六大NAND芯片厂商。长鑫存储在2021年已经实现6万片/月的产能目标,2022年将达到12万片/月,市场份额有希望提升到8%。国产存储芯片从0到1的突破给存储用国产BT载板带来了配套的机会。

2.4. 从长远来看,国产载板厂商有望因芯片制造、封测产能向大陆转移而受益。
国产半导体产业链的配套,有望让国产IC载板厂商得到成长,大陆的晶圆制造、封测配套是很重要的机遇。大陆晶圆制造产能在积极扩大,封测厂商在全球已经占据重要份额。IC insights的数据显示,在中国IC市场整体规模里,中国IC制造市场规模所占比例一直在提高,2010年是10.2%,到2021年就提升到了16.7%,预计2026年还会提升到21.2%,其规模对应的复合增速是13.3%,比中国IC整体市场规模8%的复合增速要高,与此对应的是,大陆70多条晶圆制造产业在接下来几年差不多要翻倍的扩产计划。另外,现在大陆封测厂商在全球已经处于重要地位了,2021年长电科技、通富微电、华天科技在全球市场份额的排名分别是第3、第5、第6名,加起来占比20%。国内晶圆制造和封测厂的产业链配套需求,会给国产载板厂商带来可替代的空间。
【3. 供给端:高壁垒下 ABF 载板供不应求,主要厂商扩产但供应仍受限】
3.1. IC载板有资金、技术、客户这三重壁垒,新进入这个领域挺难的。
IC载板直接跟裸芯片相接,在制造上有资金(投入大)、技术(难度高)、客户(开拓慢)这三道壁垒。资金壁垒方面:IC载板属于资金密集型产业,它复杂的生产工艺得投入大量资金购买进口设备。而且下游客户对载板厂做认证的时候,产能也是考核的一项内容。新进入这个行业的得一次性砸进去好多钱,短期内还很难有回报。2012年兴森投资的每个月能生产1万平载板的产线,设备投资差不多是5亿元,后来累计亏损超过4亿,再后来产能稳定在每个月8000平的时候,设备的资本支出也超过2.5亿元。这几年深南和兴森这两家厂商都打算投资60亿来设立高阶IC载板产线,年产能大概是2亿颗,兴森这个项目的两期产线分别会在2025年和2027年达到满产状态,年产值和投资额差不多。

技术壁垒方面:IC载板是和芯片相连的,它和普通PCB产品不一样,尺寸更小、精密度更高,在线路精细程度、孔距大小以及信号干扰这些方面的要求特别高,所以得有非常精密的层间对位技术、电镀能力以及钻孔技术。消费电子要求IC载板轻薄短小,服务器产品要求IC载板高密互联。IC载板的生产涉及材料、化学、机械、光学等好多领域的工艺技术,除了要配备先进设备,还得不断积累生产工艺和技术,这样就给新进来的企业设置了比较高的技术壁垒。
客户壁垒:IC载板下游大多是大客户,它们对质量、规模、效率和供应链安全的要求极高。对于载板这种核心零部件的采购,往往会采用「合格供应商认证制度」,对供应商的运营网络、管理系统、行业经验和品牌声誉都有比较高的要求。认证得经过生产体系认证、产品认证、小订单试用、小批量订单、大批量订单等漫长的过程,像三星的存储载板认证周期就长达24个月。而且认证通过之后,下游客户会和载板厂长期合作,没有更换供应商的想法,这对没有客户基础的新企业来说是个很明显的进入壁垒。
3.2. 全球IC载板市场比较集中,中国台湾、日本还有韩国,这三个地方的份额加起来能达到80%呢。
全球IC载板市场被少数地区集中掌控,中国台湾、日本、韩国在这当中是主要参与者,内资厂商所占份额仅仅只有5.3%。按照Prismark的统计数据,从厂商方面来讲,全球封装基板的CR10(前十大厂商的市场集中度)能达到80%,CR3(前三强厂商的市场集中度)是36%,排在前面的三大厂商分别是中国台湾的欣兴、日本的揖斐电、韩国的三星电机,它们的市场占有率依次为15%、11%、10%。从生产地来看,封装基板主要的生产地是中国台湾、日本、韩国,占比分别是31%、20%、28%,中国大陆的产值是16%,不过这里面包含了外资在中国大陆设置的产能。内资厂主要有深南、兴森、越亚、生益科技这些,在2020年的时候,它们在全球所占的比例仅仅是5.3%。
IC载板产业在集成电路产业链里,是从日本向中国台湾、韩国那边转移的,中国大陆才刚刚起步。IC载板最早是在日本出现的,一开始是BT载板在市场上占主导,揖斐电、新光和京瓷这些领先的企业就是那时候诞生的,它们和日本的半导体产业相互配套。后来半导体产业链往中国台湾、韩国那些地方转移了,IC载板产业也跟着转移过去,欣兴、景硕、南亚、三星电机等好多领先的厂商就出现了。台韩的企业有产业链配套和成本方面的优势,把日本厂商中低端产品的市场份额给占了一部分,日本的厂商就退到高端FC载板这块儿了,不过因为它们先发展起来,产业链配套比较完善,在IC载板上游的材料、设备这些领域有一定的垄断优势。三星电机的产品线主要是提供FC和射频模组载板,和本土的三星电子等厂商相互配套。中国台湾的晶圆代工产能占全球一半,南亚、景硕和欣兴这几个主要的载板厂支撑着中国台湾的芯片封装产业。中国大陆的集成电路产业开始得比较晚,所以产业链配套还不完善,IC载板厂商还在起步阶段呢。
3.3. ABF载板的需求很大,供应却跟不上。主要的载板厂虽然打算扩大产量,但预计供应还是会受限。

日本味之素完全垄断上游的ABF薄膜材料,它扩产意愿不强,这就限制了ABF载板产能的增长。ABF载板上游的主要基材是ABF薄膜,味之素在ABF薄膜产能方面是完全垄断的。这种产品是其味精产品的副产物,绝缘性能特别高,能满足高性能芯片高密连接时线路互不干扰的要求,被英特尔率先使用,不过到现在还没有能大规模量产的替代品。虽然味之素公司已经说要增产了,但增产的规模比较保守。味之素在2021年6月宣布,未来四年的复合年增长率(CAGR)是14%,这个速度比ABF载板需求的增长速度要慢。高阶ABF载板面积变大后,良率就降低了,这对供给是进一步的限制。随着芯片尺寸变大,输入/输出(I/O)的数量增加,更高阶的ABF载板面积更大、层数更多、复杂程度更高,这些都让产品良率大大降低了。经测算,66厘米载板的良率只有30 - 50%,更大面积的设计也很常见,所以实际供给增加的速度会比产能扩充的速度慢。
兴森科技主要做线路板产业链方面的事,有PCB和半导体这两个大方向。PCB业务大多是小批量样板,半导体包含IC载板和半导体测试板。2021年的时候,这个公司总的营收是50.4亿元,跟之前比增长了25%,归属于母公司股东的净利润是6.21亿,比之前增长了19%。IC载板业务的营收涨得很快,比之前翻了一倍,达到6.67亿元,在总营收里占13%,这主要是广州基地每个月2万平米的产能释放带来的效果,这个基地已经是满产满销了。它的毛利率也提高到了26.35%,和之前比增加了13.35个百分点。

公司在2012年就开始对IC载板产品进行布局了。2018年9月的时候,通过了三星的认证,成了三星的正式供应商,而且是唯一的大陆本土IC封装基板供应商呢。现在主要做的是BT类载板,ABF(用于FCBGA)载板的产能还在建设当中。从下游应用来看,存储占了三分之二,其他的占三分之一;客户方面以大陆为主,占三分之二,台韩客户占三分之一。在BT载板这块,广州基地每个月产能是2万平,已经满产满销了,良率达到96%。珠海兴科和大基金合作的项目分两期投资。一期计划每个月4.5万平,其中首条生产线每个月1.5万平在4月试产;后面会分批建设每个月3万平的产能,预计到2023年底投产。说到FC - BGA载板,2月有公告说要在广州基地投资60亿建FCBGA项目。一期产能是每个月1000万颗,预计2025年达到满产状态;二期产能也是每个月1000万颗,预计2027年达到满产状态,全部满产的产值能有56亿。现在已经开始建设前期的准备工作了,设备采购工作也同步启动了。2022年6月还公告说打算在珠海投资12亿建设每个月200万颗(也就是每个月6000平)的FCBGA封装基板项目,满产产值16亿,预计会比广州项目提前一年投产。
4.2. 华正新材:BT树脂已经开始量产出货了,FC - BGA胶膜也起步进行研发了。
华正新材主要做覆铜板业务。2021年的时候,公司扩产了,产品也涨价了,这就使得营收增长得很快。而且呢,公司还大力扩产铝塑膜,这种铝塑膜是能用在软包电池上的,软包电池在消费类产品和新能源汽车上都能用。2021年公司营收是36.2亿,和上一年比增长了58%;毛利率是16.51%,跟上一年比降低了2.41个百分点;归母净利润是2.38亿,比上一年增长了90%。
公司在IC载板材料这块,主要布局了类BT/BT基板树脂材料和CBF积层绝缘膜。类BT/BT树脂已经开始量产并且出货了,它有不少特性,像Tg挺高(255到330°C)、耐热性在160到230°C、抗湿,还有低介电常数(Dk)和低损耗(Df)这些,能用于Chip LED、Mini背光显示、COB白光器件、Mini RGB器件以及内存封装等。7月20号的时候,公司发公告说要和深圳先进电子材料国际创新研究院一起出钱成立个合资公司(公司出5200万元),搞CBF积层绝缘膜的研发和销售。这CBF积层绝缘膜可是在先进封装领域很关键的封装材料,像FC - BGA高密度封装基板、芯片再布线介质层、芯片塑封、芯片粘结、芯片凸点底部填充等重要场景都能用得上。日本企业在这方面的市场占有率差不多有96%,国内企业替代它们的空间很大。
4.3.深南电路:它可是MEMS载板方面的龙头企业,正在扩大高端FC - BGA载板的产能呢。
深南电路是内资PCB行业里领先的龙头企业,主要有印制电路板、封装基板和电子装联这三项业务,这样就有了独特的「3 - In - One」业务布局。2009年的时候,公司进军半导体封装基板领域,有了自己的封装技术和工艺,而且这些都是有自主知识产权的,现在已经是日月光、安靠科技这些封测大企业的合格供应商了。2021年,公司总共营收是139.43亿元,和上一年比增长了20%,归属于母公司的净利润是14.8亿,同比增长3%,毛利率是23.71%,同比下降2.76个百分点。IC载板业务的营收有24.15亿元,在总营收里占比17.3%,这个增长速度很厉害,同比增长56%,比整体营收的增长快多了。这两年公司IC载板业务的毛利率慢慢涨到了29.09%,比整体的毛利率高出5.38个百分点,已经成了重要的收入和利润来源了。

公司的封装基板产品有硅麦克风微机电系统封装基板、射频模组封装基板、高端存储芯片封装基板,还有高速通信封装基板。硅麦克风微机电系统封装基板在苹果、三星等智能手机里大量使用,市场占有率超30%。公司现在在深圳有两家、在无锡有一家封装基板工厂。深圳的工厂主要做MEMS微机电系统封装基板、指纹模组、RF射频模组等封装基板产品;无锡的工厂主要做存储类封装基板,而且有FC - CSP产品技术能力。2021年的时候,公司在广州和无锡建载板厂来增加产能。广州的工厂打算投资60亿,做FC - BGA(ABF基板)、FC - CSP、RF等基板,预计23年底能投产,产能大概是2亿颗FC - BGA、300万panel RF/FC - CSP等有机封装基板;无锡的工厂打算投资20.16亿,做高端存储、FC - CSP等基板,预计22年第四季度投产。
4.4.生益科技:这是一家在全球都领先的覆铜板企业,它正在向下游的IC载板基材和胶膜方面拓展业务。
生益科技在全球覆铜板领域处于领先地位。从2013年到现在,硬板的累计销售额在全球排第二,全球市场占有率差不多稳定在12%。2021年的时候,公司的营业收入达到203亿元,跟去年相比增长了38%;归属于母公司的净利润是28.3亿元,同比增长68%;毛利率为26.82%,和去年相比基本没什么变化。

4.5.胜宏科技:它是内资PCB方面的龙头企业,要通过定增来扩大对IC载板的投资。
胜宏科技在2006年成立,它的主要产品是双面板、多层板(HDI),下游的应用范围很广。胜宏科技在全球PCB百强排行榜里排第25名,在中国PCB企业排行榜内资企业里排第4名。2021年的时候,公司的营收达到74亿,和上一年比增长了33%;归母净利润有6.7亿,同比增长29%;毛利率是20.37%,不过和上一年比下降了3.29个百分点。
2021年8月24日发了个公告,说要向特定对象发行股票,打算募集的资金不超过20亿。这里面呢,有15亿再加上自有资金,总共29.9亿,要投入到高端多层、高阶HDI印制线路板还有IC封装基板的建设项目里。这个项目建成之后啊,预计高端多层板的产能能达到每年145万平方米,高阶HDI能达到每年40万平方米,IC封装基板能达到每年14万平方米。
(本文仅供参考,不表示我们有任何投资建议。要是想使用相关信息,请查看报告原文。)
精选报告来源:【未来智库】。未来智库 - 官方网站











