半導體技術
積體電路產業的持續發展帶來了半導體制程技術的不斷進步。隨著線寬的縮小,晶體管體積減小,使得在相同面積上能夠整合更多的電路,從而提升了芯片的效能。然而,線寬的減小也帶來了挑戰,如路線短路或開路的缺陷尺寸更小,良率的提升變得更加困難。透射電子顯微鏡(TEM)因其高分辨率和精確度,在半導體積體電路失效分析領域扮演著重要角色。一下是制備步驟:

在制備TEM樣品時,聚焦離子束(FIB)技術因其定位準確、切割精度高、制樣速度快和成功率高而廣泛套用。為了方便對材料進行深入的失效分析及研究,金鑒實驗室具備Dual Beam FIB-SEM業務,包括透射電鏡( TEM)樣品制備,材料微觀截面截取與觀察、樣品微觀刻蝕與沈積以及材料三維成像及分析等。
FIB制樣過程中,離子束能量、離子束電流、刻蝕時間等參數共同決定了刻蝕的形狀和深度。然而,不當的制樣條件可能會引入人工缺陷,影響TEM分析結果的準確性。
實驗與分析
透過實驗分析了FIB制樣條件對TEM樣品形貌的影響,包括制造工藝、離子束切削參數、保護層沈積條件等。研究發現,離子註入工藝和FIB制樣條件可能共同作用導致樣品缺陷。
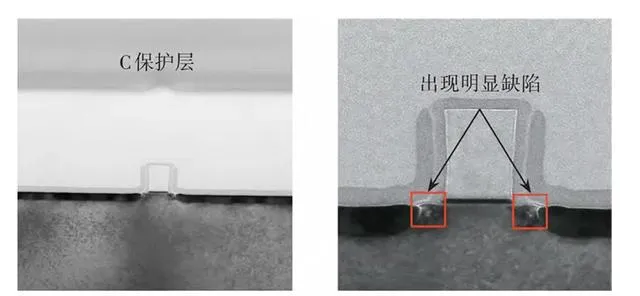
FIB切削能量並非引起樣品表面缺陷的主要原因,而電子束輔助沈積保護層的條件對樣品表面形貌有顯著影響。透過最佳化電子束能量參數,並使用原子品質較大的材料作為保護層,可以有效減少由熱損傷引起的缺陷。

FIB常規條件制備樣品的TEM圖
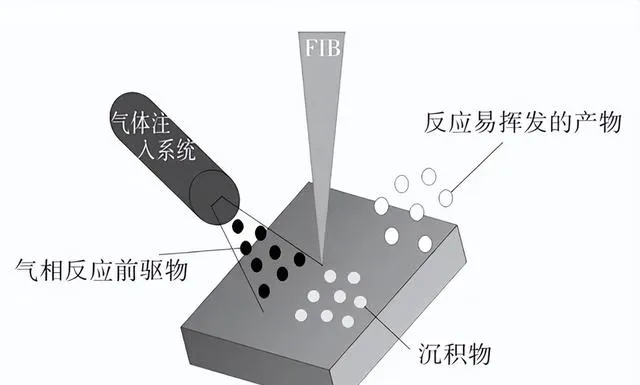
FIB系統輔助沈積保護層原理圖
這些發現對於最佳化FIB制樣條件、提高TEM樣品品質、降低產品缺陷率以及提升積體電路制造過程中的良率具有重要意義。透過深入理解FIB制樣條件對樣品形貌的影響,可以為失效分析提供更準確的數據支持,進一步推動積體電路產業的發展。











