電子能量損失光譜(EELS)涉及分析與樣品交互作用後初始單能電子的能量分布。這種交互作用有時局限於幾個原子層,就像一束低能量(100-1000 eV)的電子從固體表面「反射」出來一樣。由於不涉及高壓,裝置相對緊湊,但低穿透深度意味著使用超高真空。否則,資訊主要是從樣品表面的碳質或氧化物層獲得的。
在這些低初級能量下,單色儀可以將初級光束的能量擴散降低到幾毫電子伏,如果光譜儀具有相當的分辨率,則光譜包含與表面原子的振動模式進行能量交換的特征,以及這些原子中的價電子激發。因此,該技術被稱為高分辨率電子能量損失光譜(HREELS), 用於研究表面和吸附原子或分子的物理和化學。
電子能量損失光譜只是眾多可用於確定固體結構或化學成分的技術之一。下面列出了一些能夠實作高空間分辨率的技術。每種方法都采用了眾所周知的物理原理,但只有當合適的儀器可用時,才能作為微觀分析工具發揮作用。
利用電子、離子和光子光束的成像和分析技術可實作的空間分辨率
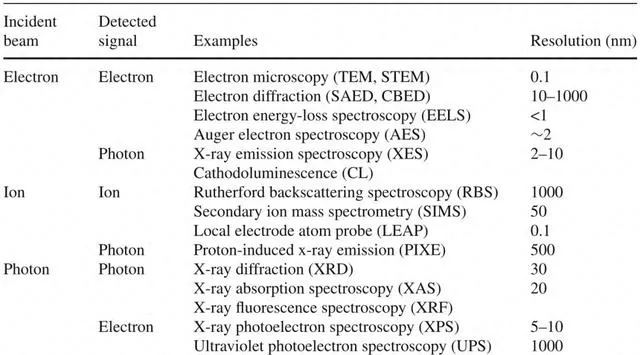
01 電子能量損失譜原理介紹
EELS是利用入射電子束在試樣中發生非彈性散射,電子損失的能量DE直接反映了發生散射的機制、試樣的化學組成以及厚度等資訊,因而能夠對薄試樣微區的元素組成、化學鍵及電子結構等進行分析。
圖1 測試原理圖
當電子穿過樣品時,它們會與固體中的原子交互作用。許多電子在穿過薄樣品時不會損失能量。一部份在與原子交互作用時會發生非彈性散射並損失能量。這會讓樣品處於激發態。材料可透過分析通常以可見光子、X 射線或奧杰電子形式存在的能量實作去激發。
將要研究的材料置於電子顯微鏡中,用一束動能分布很窄的電子轟擊。一部份入射電子經歷非彈性散射,其動能發生改變(通常是減小)。動能損失的機理有很多,包括:電子-聲子交互作用,帶內或帶間散射,電子-電漿交互作用,內殼層電子游離,及契忍可夫放射線。電子的能量損失可以被電子譜儀定量的測量出來。內殼層電子游離引起的非彈性散射對於分析材料的元素構成尤為有用。比如, 碳原子的1s電子游離能為285eV。如果285eV的動能損失被探測到,則材料中一定存在碳元素。
下面介紹EELS的套用:
02 試樣厚度測量
通常,如果需要知道TEM樣品的局部厚度,可以將EELS或EDX分析提供的面密度轉換為元素濃度,或從TEM影像估計缺陷濃度。包括以下幾種方法:
1.Log-Ratio方法。 在入射光束(或區域選擇孔徑)定義的區域內估計樣品厚度的最常用方法是記錄低損耗光譜,並將零損耗峰下的面積I0與整個光譜下的總面積It進行比較。
2.K-K求和法則的絕對厚度。 能量損失譜的Kramers-Kronig分析給出了絕對試樣厚度的值,以及與能量相關的介電數據,而不需要樣品的化學成分。
3.貝斯和規則的品質厚度。 透過適當的校準,還可以透過對選定散射角和能量損失範圍內的非彈性散射進行積分,使用電子能譜儀剔除彈性和非散射分量,從而獲得局部品質厚度,可以作為STEM和ADF探測器測量高角度彈性散射的低劑量替代方案。
03 低損耗光譜
能量損失譜的1-50 eV區域包含由外層電子的非彈性散射引起的峰。在大多數材料中,主峰可以稱為電漿峰;其能量與價電子密度有關,其寬度反映了單電子躍遷的阻尼效應。
在某些情況下,這些躍遷直接出現在低損耗譜中,作為疊加在電漿峰上的峰或精細結構振蕩。低損耗譜是電子束內材料的特征,如果有合適的比較標準,並且光譜數據具有足夠低的雜訊水平,則可用於辨識該材料。
1.低損耗精細結構鑒定
如果樣品包含產生尖銳電漿峰的區域,則很容易辨識所涉及的材料,如金屬鈉、鋁或鎂。 其他材料更難表征,因為它們的電漿峰很寬,發生在有限的範圍內,通常為15-25 eV。
然而,透過與候選材料記錄的低損耗光譜進行仔細比較,有時可能會辨識出未知的相位。這種指紋辨識方法被用來辨識內部氧化的Si/Ni合金中25-250 nm的沈澱為無定形SiO2 和矽中10-100 nm的沈澱為SiC。
由於多重散射,低損耗光譜的整體形狀取決於樣品的厚度,因此為了避免未知材料和參考材料之間的厚度差異造成的誤差,應該消除多重散射,例如透過傅立葉對數反褶積。
許多有機化合物在主電漿峰值以下的能量處具有獨特的精細結構,見圖2。但是, 如果結構不突出,則使用多個最小平方擬合進行仔細比較可以測量成分。

圖2 薄膜中測量能量損失函式中的低損耗精細結構
2.電漿能量和合金成分的測量
當合金元素被添加到金屬中時,晶格參數和/或價可能會改變,導致價電子密度和電漿能量Ep的變化。對於給定的合金體系,使用已知成分的校準樣品,可以透過實驗確定其在Ep中的強度。在某些情況下,電漿激元能量隨成分x線性變化。
為了使訊雜比最大化, 試樣厚度應大致等於電漿平均自由徑 ,因此應避免使用超薄試樣。但在較厚的樣品中,雙散射峰的尾部取代了第一電漿峰,使其能量損失更高;反褶積是必要的,以消除多重散射和確保可重復性。表面氧化物或汙染層也會引起峰值位置的移動,但透過仔細的樣品制備和清潔的真空條件可以將其最小化。如果樣品是結晶的,應避免強繞射取向。
電漿位移法已被用於證明晶界處的溶質損耗,估計擴散常數,並檢查飛濺冷卻合金中的溶質再分配。
電漿位移方法也被套用於金屬-氫系統,其中氫通常在電漿能量中引入向上的位移。對於這些系統,自由電子公式給出的電漿能量通常低至1-3 eV,但預測金屬和氫化物自由電子值之間的差異有時與觀測結果非常吻合。這些電漿位移研究的重要性在於, 分散的氫無法透過WDX或EDX光譜檢測到,而鋰的量化很難透過核心損耗EELS或EDX進行檢測。
3.小顆粒的表征
由於小粒子具有高的表面體積比,它們的激發由局域表面電漿模式主導。
表面模式散射涉及低於體積電漿峰值的能量損失;這種散射的細節取決於界面的幾何形狀和與能量相關的介電常數的不匹配。在小探針和單個球形顆粒的情況下,低損耗譜取決於探針的位置,並且對於金屬球體和覆蓋有氧化層的球體是不同的。
小粒子中的電漿模式在光訊號處理、生物傳感和癌癥治療等方面有著重要的套用,現代TEM-EELS系統為研究這些模式提供了很好的工具。

圖3 對銀粒子的STEM能量濾波影像
對於三角形銀粒子,最低能量(1.75 eV)模式在粒子的角落處振幅最大,在邊緣處振幅為2.7 eV,在幾何中心周圍振幅為3.2 eV,如圖3a所示。使用邊界元計算的模擬得到了非常相似的強度分布(圖3b)。
透射電鏡的橫截面樣品對比不大,Si和SiO2的平均自由徑非常相似,但電漿激元能量相差很大 :Si為17 eV,而SiO2為23 eV。能量選擇斷層掃描被用來提供三維視覺化,透過記錄一系列的TEM影像在標本傾斜高達±60°在4°增量。電腦軟體允許對17±2 eV影像進行三維對齊和重建,如圖4a所示。
正如離域電漿散射所期望的那樣,粒子本身具有柔軟的輪廓,但它們是透過選擇閾值強度來描繪的,其輪廓如圖4所示為網格影像,揭示了粒子的不規則形狀。這種復雜的形貌與該材料所觀察到的光致發光和電致發光的寬光譜範圍是一致的,而每個顆粒的大表面積可能是發光效率高的原因。
圖4 利用電漿能量差異的類似層析成像
利用電漿能量差異的類似層析成像技術已被套用於生成聚合物(尼龍)基體內碳奈米管的三維影像 。也可以將來自輕元素的電漿訊號與同時獲得的HAADF訊號(來自重元素)結合起來,以顯示兩者的分布。如圖4b所示,這是透過FIB銑削制備的針狀試樣記錄的復合層析影像。
04 能量過濾影像和繞射模式
1.零損失影像
透過在繞射耦合模式下操作光譜儀(用於成像的TEM組)並調整光譜儀激發或加速電壓,使零損耗峰透過能量選擇狹縫,產生比正常(未濾波)影像具有更高對比度和/或分辨率的零損耗影像。
造成這種改善的主要因素如下:它們的相對重要性根據樣品型別以及是否涉及常規TEM或STEM而變化。
2.零損耗繞射圖
繞射圖的能量濾波可以透過傳統TEM中的成像濾波器來完成,比透過非成像光譜儀的入口孔徑掃描繞射圖要有效得多。 零損耗濾波消除了非彈性(主要是電漿)散射產生的漫射背景,使微弱的繞射特征更加明顯。
由於非彈性散射在小角度時最強,濾波對於低角度繞射應該特別有利,從而提高對具有大晶胞的材料的分析,例如大分子的周期性陣列或非周期性奈米結構。濾波也被用於提高透射電鏡中記錄的反射繞射圖樣的可見性,並有助於對會聚光束繞射強度的定量分析。
3.低損耗的圖片
具有尖銳電漿峰的材料的空間分布可以透過在相應的能量損失處形成影像來顯示。
表面等離子激元激發的非彈性散射提供了低於體積等離子激元峰值能量的強度。在這種能量損失下,小粒子顯示出明亮的輪廓,因為表面等離子激元激發的機率對於以掠過角度傳播到表面的電子來說更大。 如果在非均勻樣品的低損耗光譜中看到一個未辨識的峰,則在該能量損失處形成影像可以幫助確定它是否來自表面模式散射。
一些有機染料(發色團)在幾個電子伏特的能量處具有吸收峰,對應於可見光或紫外線光子,並且可以在光學顯微鏡中用作化學特異性染色。透過形成相應能量損失的影像,可以在能量過濾電子顯微鏡中以高空間分辨率繪制它們的分布
4.Z-Ratio圖片
透過去除零損耗成分的電子光譜儀測量高角散射(由環形探測器記錄)和低角散射的比率,形成z比STEM影像。 對於非常薄的樣品,暗場訊號主要代表彈性散射,而光譜儀訊號則來自非彈性散射。
因此,比值影像中的強度是局部彈性/非彈性散射比的度量,它大致與局部(平均)原子序數Z成正比。其目的通常是為了區分元素組成的差異,同時抑制試樣厚度變化和入射光束電流波動的影響。
5.對比度調整和MPL成像
對比度調整是指選擇能量損失(通常在0-200 eV範圍內)的能力,其中對比度足夠,但足以在單個顯微照片中記錄影像。動態範圍有時是零損耗影像厚(例如,0.5 μm)生物組織切片的問題,因為染色區域相對於未染色區域散射非常強。
生物組織中的結構敏感對比度有時可以透過選擇250 eV左右的能量損失來最大化,剛好低於碳的k邊,這樣碳對影像的貢獻就最小化了。 含有較低邊緣元素(硫、磷或重金屬汙物)的結構在影像中顯得明亮,形成反向的「暗場」對比。
05 核損耗光譜的元素分析
鐵芯損耗訊號的量化需要將其與背景分離。
最簡單的方法是透過在前邊緣區域內擬合來模擬前邊緣背景,在邊緣之後的能量視窗(通常為50-100 eV)上積分芯損耗訊號時考慮到該背景。 當兩個或更多的邊緣能量接近,或者當一個元素以低濃度存在,或者在一個不是很薄的樣品中處於低能量邊緣時,這個過程就會出現問題。
在這種情況下,透過對背景和邊緣分量的多重最小平方(MLS)擬合可以更成功地模擬核心損耗訊號。通常,標準試樣用於記錄邊緣形狀,而計算截面用於推導元素比。另一種方法是透過減去樣品附近區域記錄的光譜來研究濃度差異。
為了確定元素比,必須在無標準程式(使用計算或參數化的橫截面和基於標準的(k因子)方法。無標準的方法很方便,但要求收集半形是已知的,至少是近似的。k方法使用一個或多個已知成分的標準樣品,其中包含每個分析元素。如果未知樣品和標準樣品使用相同的值,則不需要入射光束能量和收集角度。一些系統誤差的來源,如鮮為人知的橫截面和色差效應,在使用k因子方法時可以消除。
雖然核心損耗光譜原則上可以辨識元素周期表中的任何元素,但有些元素比其他元素更容易被檢測到。 EELS最常用於分析低原子序數的元素,這類元素難以用EDX光譜定量。
06 空間分辨率和檢測限
在能量損失光譜或能量過濾成像中獲得的空間分辨率取決於幾個因素,現在要討論。在爐心損耗微分析的情況下,空間分辨率與元素檢測限的概念密切相關。
可以透過EELS辨識原子序數的單原子影像 ,如圖5a。釓(Gd)原子被放置在C82富勒烯分子中,而C82富勒烯分子又被包裹在單壁碳奈米管中(形成所謂的豆莢)。原子受到空間限制,次級電子(在富勒烯和有機化合物中造成大部份損害的電子)可以自由逸出。即便如此,原子數的評估(從背景減去Gd n邊)得到的數值在0到4之間,表明在強輻照下,一些Gd原子沿著奈米管遷移並聚集在一起。隨後在60 keV下的測量表明,沒有觀察到Er原子的運動,盡管Ca原子影像的強度比l殼層截面的預期強度低300倍,表明在電子暴露過程中有運動出束。

圖 5 辨識晶體的單個原子
研究者使用像差校正的STEM辨識了晶體CaTiO3中的單個La原子,見圖5.33c。據說訊雜比足以確定單個原子的電子性質(例如,價電子)。作者指出,由於通道的存在, 不同元素訊號的強度隨深度的變化而不同 ,這可以透過與電腦模擬探針擴散的比較來確定原子的深度。
07 來自EELS的結構資訊
固體中的非彈性散射對樣品的晶體學和電子結構以及元素組成都很敏感。因此,結構資訊可以從非彈性強度對試樣取向的依賴,從散射的角度依賴,或從存在於能量損失譜的低損耗或核心損耗區域的精細結構中獲得。
1.游離邊的取向依賴性
在晶體樣品中,透射電子波函式可以寫成布洛赫波的和,內殼激發的機率正比於這個和的模的平方。總強度分布具有晶格的周期性,節點和天線在每個單元胞內的位置是晶體取向的敏感函式。
在能量損失較高的情況下,來自內殼層的電子散射位於每個原子的中心附近,因此,當樣品沿垂直於入射光束的軸傾斜時,核心損失強度將發生變化。在x射線研究中,這被稱為博爾曼效應。雖然它代表了晶體材料的EELS元素分析中的一個誤差來源,但它可以建設性地用於確定特定元素的晶體位置,透過其游離能選擇。
在EELS的情況下,引起內殼激發的初級電子在被檢測到之前可能會在樣品內進一步移動。 在這樣做的過程中,他們再次受到引導,這影響了他們在特定方向逃跑的可能性(一種被稱為阻擋的效果)。如果以入射光束方向為中心的收集孔徑來定義該方向,則晶體對非彈性散射電子的阻擋作用增強了入射光束的通道(相當於粒子通道實驗中的雙對準),並且EELS觀察到的取向依賴性可能比x射線發射光譜中觀察到的更大。
通道實驗需要包含與入射光束直徑一樣大的單晶區域的樣品,通常是幾奈米,因為較小的探針的收斂會降低取向效應。試樣厚度應至少等於消光距離,以便在每個單元胞內提供電流密度的顯著變化。否則,方向依賴性較弱,測量結果容易產生統計誤差。消光距離不僅與入射電子速度成正比,而且還取決於晶體取向和原子序數。
2.核損耗繞射圖
非晶試樣具有軸對稱散射分布;在低能量損失情況下,強度在非散射方向上達到峰值,而在遠高於游離閾值的能量損失情況下,強度以擴散環的形式出現。在晶體樣品的情況下,彈性散射導致包含布拉格斑點(或環,對於多晶體)和菊池線或帶的繞射圖樣。
在掃描透射電子顯微鏡中,透過以一定角度搖擺入射光束或使用樣品後偏轉線圈透過小孔徑探測器掃描繞射圖案,可以記錄能量過濾的繞射圖案,但更有效的方法是使用固定入射光束和成像濾波器。
在低能量損失時,繞射圖類似於零損耗圖,但繞射斑被非彈性散射的角寬度加寬。
3.ELNES特征
在含有配位鍵的化合物中,如礦物和有機配合物,有時需要知道金屬離子周圍最近鄰配體的配位數和對稱性。游離邊緣的能量損失近邊結構(ELNES)近似表示產生該邊緣的原子處的局部態密度。這種解釋與發射電子後向散射的多重散射(XANES)計算是一致的,該計算表明,散射是相當局部的,只涉及幾個鄰近的殼層。
有時,被射出的核心電子的散射主要來自原子的單殼層,這些原子是強散射的物質,如O2-或F-離子。實際上,離子形成了一個籠子或勢壘,阻礙了內層電子的逸出。然後,當套用於礦物標本時,近邊緣精細結構可以作為配位指紋。
在聚合物和大分子的情況下,XANES結構可以提供作為整個結構構建塊的官能團的指紋。 散射是局域化的這一事實使得分子軌域計算可以作為解釋和標記峰的基礎。

圖 6 含碳酸鹽陰離子的礦物的碳k邊與單質碳的k邊比較
圖6所示為受激原子處於三角形平面配位(三個最近鄰位於一個平面內)的ELNES。碳化物基團的碳k邊的特點是π *峰較窄,在10-11 eV分離時,σ *峰較寬,與任何單質形式的碳的精細結構大不相同。在棱柱狀(非平面)配位中和在菱鐵礦中的三角配位硼中也觀察到同樣的k邊精細結構。
08 特定材料的套用
1.半導體及電子器件
隨著半導體器件向奈米尺寸縮小,TEM-EELS在研究其材料特性方面變得越來越有用。例如,了解器件內半導體或電介質的帶隙如何變化是很重要的。除非提供的能量超過直接帶隙(通常為1ev或更多),否則半導體或絕緣體中的偶極子躍遷不會發生。因此,能量損失譜應該顯示為零強度,隨後在帶隙能量Eg處急劇上升,從而提供Eg的測量。
在實踐中,有兩個問題。 首先,在薄樣品中,零損耗峰非常強,其尾部可以延伸到幾個電子伏特。
透過使用配備單色儀的TEM和將平行記錄光譜儀設定為足夠高的能量色散(低電子伏特/通道),可以最小化這些尾。即便如此,通常需要透過擬合和減法或傅立葉比反摺積來去除高e尾。
有研究者透過對強度上升與其之前的背景進行線性擬合,從交點選取Eg,實作了測量不同厚度SiO2薄膜帶隙的一致性,見圖7。
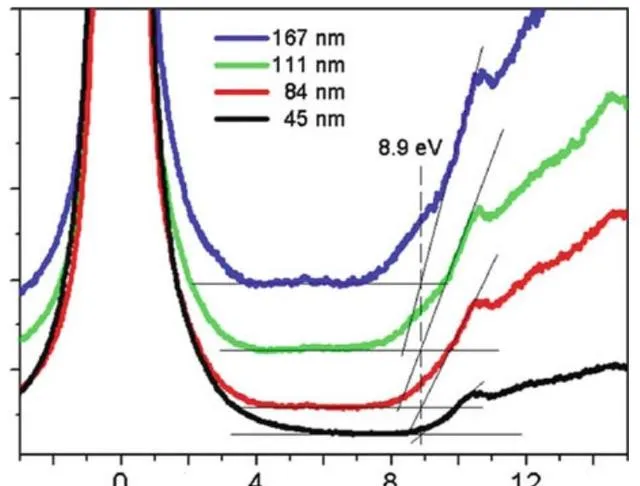
圖7 TEM-EELS系統測量不同厚度氧化矽薄膜的帶隙
2.陶瓷和高溫超導體
在Si3N4結構陶瓷中,力學和熱效能受晶體/非晶界面的原子和電子結構的控制,其中可能發生原子間混合和重陽離子的部份排序。
研究者利用EELS獲得了β-Si3N4SiO2界面上光原子的位置資訊。圖8a顯示了原子分辨率的亮場影像,顯示了晶體β-Si3N4和非晶態SiO2之間存在短程有序。為了辨識沿界面和跨界面的成分,在80 kV(避免放射線損傷)下, 透過光柵掃描像差校正探針進行原子分辨EELS ,同時在每個像素處收集光譜(0.05 s)。圖8d, e顯示了同時獲取的z -對比度影像中從六個不同位置獲取的Si-L23邊緣。

圖8 原子分辨率EELS分析
在所有六個位置的矽訊號都顯示出Si-N和Si-O鍵的特征(Si3N4和SiO2參考光譜的峰a、b和c),但在位置1、2、3和4顯示出更強的Si-O鍵,因為105eV的峰(標記為b)更明顯。在位置4和6的Si訊號,代表終止Si3N4結構的兩端,有細微的不同特征,表明不同的鍵合特征。為了進一步研究,O和N k邊與Si L23邊同時獲得,並透過在40 ev視窗內積分這些訊號,計算元素O/N比,如圖8g所示。
3.碳基材料
當石墨樣品的厚度減少時,體電漿(7和27 eV)的峰值最終會發生紅移,在單石墨烯層的情況下約為5和14.5 eV。這些變化與使用局部密度泛函碼的計算結果基本一致(。它們也可以被視為從體電漿到表面電漿的變化,記住兩個表面模式是高度耦合的,並且色散使峰值依賴於q。
單層石墨烯 的面外模式(q||c)趨近於零,其π等離子激元呈現線性色散。對於兩層材料也觀察到線性色散,但對於三層材料則更接近於二次色散。單層材料的電子繞射圖不存在高階勞厄帶,且隨試樣取向變化不大。當入射電子能量超過60 keV時,石墨烯會受到撞擊過程的破壞。
碳奈米管 是一種卷起來的石墨烯片,上面覆蓋著類似富勒烯的末端結構,存在於單壁(SWCNT)和多壁(MWCNT)形式。單壁碳奈米管π共振能量(15 eV)接近單層石墨烯,呈現線性色散,而4 eV以下的帶間躍遷則不表現色散。隨著壁厚的增加,介電效能越來越接近石墨。
富勒烯 是在由碳蒸氣凝聚而成的煤煙中發現的,它是由彎曲成球形或橢球形的石墨狀薄片組成的分子。固體形式(富勒石)可以用苯提取,或者透過將沈積物昇華到襯底上以形成薄膜。C60富勒石的能量損失譜在25.5 eV處有一個主(σ +π)電漿峰,在6.4 eV處有一個π共振峰,還有幾個副峰。
金剛石 結合了高硬度,導熱性和折射率(2.4),非常低的導電性和對可見光的透明度。天然鉆石是根據紅外光譜進行分類的:與II型鉆石不同,I型鉆石含有相當數量的氮,要麽是分離的(Ia型),要麽是分散的(Ib型)。
在薄樣品中,發生在碳k邊前約5 eV的強度小幅上升(例如,圖5.37)更為突出,並且可能與石墨表面層的帶隙或π *水平內的表面狀態有關。使用空間差分EELS檢測到當電子束被放置在位錯附近時,在前邊緣區域有額外的強度,這可能表明激發到缺陷或雜質狀態。在金剛石的{111}自由表面存在一層氧,這是根據對反射模式能量損失光譜中的氧k邊的觀察推斷出來的。
4.聚合物和生物標本
光譜成像在光譜采集後提供了廣泛的數據操作的可能性。例如,它允許分割用於測量特定胞器中的小濃度元素。 可以透過檢查主要成分(C、N、O)的k邊來辨識相似組成的區域 ,並將這些區域的光譜相加,為測量平均微量元素濃度提供足夠的統計數據。
5.放射線損傷和鉆孔
放射線損傷為電子束分析的空間分辨率提供了一個基本的物理限制,因此最小化這種損傷是很有意義的。。
電子在TEM樣品中經歷彈性和非彈性散射 。100 mrad以下的彈性散射,用於形成繞射圖案和亮場影像,涉及可忽略的能量傳遞(<0.1 eV),並且不會損壞樣品。然而,透過較大角度散射的電子可以傳遞幾個電子伏特的能量,如果入射能量超過某個閾值,則會導致位移(或撞擊)損傷。
高角度散射是一種罕見的事件,因此撞擊損傷僅在高電子劑量(典型>1000 C/cm2)下才重要,並且僅在導電材料(特別是金屬)中才值得註意,在那裏高密度的自由電子可以防止放射線分解造成的損傷。其結果是晶體內或晶界處原子的永久位移和從樣品表面去除原子(電子誘導濺射)。在後一種情況下,薄碳表面塗層已被證明在有限的時間內有效地保護試樣。











