今天分享的是AI行业系列深度报告(二): 【HBM,高带宽特性释放AI硬件性能,AI高景气持续驱动需求高增】 ,(报告出品方:平安证券) 。
精选报告来源:幻影视界
研究报告内容摘要如下
HBM是当前AI时代首选的内存技术
AI时代下高带宽存储需求激增,HBM技术正步入快速发展阶段。HBM(High Bandwidth Memory ,高宽带内存)采用硅 通孔( TSV)技术将多个DRAM芯片进行堆叠,并与GPU一同进行封装,形成大容量、高位宽的DDR 组合阵列,从而克 服单一封装内的带宽限制。相较于传统DDR内存,HBM 具有高带宽、低功耗、低延时等优势,已成为当前高性能计算、 人工智能等领域的首选内存技术。以英伟达p00 SXM5为例,其集成了6颗HBM3,总容量达到80GB ,内存带宽超 3TB/s,是A100内存带宽的2倍。

三大原厂持续扩充HBM产能,SK海力士位居全球市场份额首位。当前AI高景气不断驱动HBM需求高增,持续推动HBM位元出货量和产值同步增长,根据Yole 预测数据,预计2025年全球HBM位元出货量和行业产值将分别达到17亿GB和199亿美元。竞争格局方面,根据TrendForce 数据,以位元出货量作为统计口径, 2023年全球HBM市场中,SK海力士和三星的市场份额各占47.5%左右,而美光份额约为5%。随着HBM3e的率先推出及放量,预计2024年SK 海力士的市场份额 将增加至52.5%,而三星的市场份额将下降至42.4%。为了满足持续增长的HBM需求,三大原厂纷纷加大资本开支扩建HBM产能,其中,三星和SK 海力士的产 能扩充最为积极,预计到2024年底,三星HBM总产能将达约13万片/月,SK海力士约12万片/月,而美光仅为2万片/ 月。
TSV技术是HBM实现芯片垂直堆叠的核心工艺
HBM加工制造流程主要包括前端晶圆制造加工,以及后端Bumping、Stacking和KGSD 测试环节。其中,相较于平面 DRAM的制造流程,TSV(硅通孔)技术是HBM实现芯片垂直堆叠的核心工艺。
报告原文节选如下:







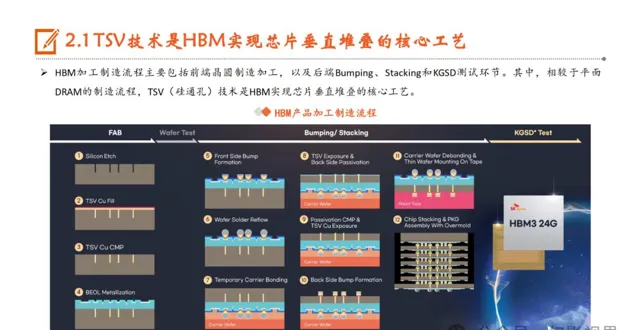


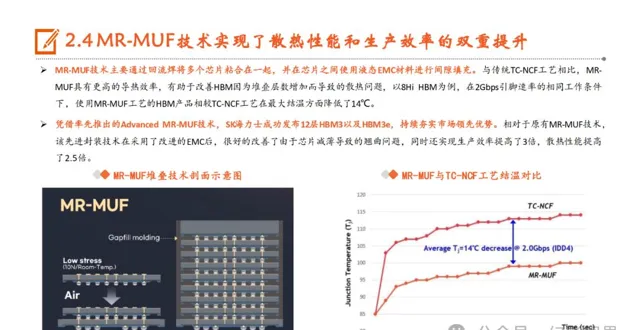

本文仅供参考,不代表我们的任何投资建议。幻影视界 整理分享的资料仅推荐阅读,用户获取的资料仅供个人学习,如需使用请参阅报告原文。











