在追求高性能电子器件的今天,碳化硅以其卓越的物理和电学性能,成为了制造电力电子器件的理想材料。然而,碳化硅衬底在 抛光工艺 上还面临着成本、环保等方面的难题,一直是制约其广泛应用的瓶颈。
传统CMP(化学机械抛光)需要使用大量的 抛光液材料 ,抛光液成本占抛光环节成本比例较大,这不仅增加了 生产成本 ,也对 环境 造成了负担。
近日,日本立命馆大学(Ritsumeikan University)一研究团队开发了一种新型的 ECMP(电化学机械抛光) 技术,可带来3大技术优势:
● 环保高效:ECMP技术避免了使用有害的液体化学物质,减少了对环境的影响;
● 高材料去除率:该技术实现了约15µm/h的材料去除率(MRR),是传统CMP的 10倍 。
● 表面质量高:通过ECMP处理的碳化硅衬底表面光滑,粗糙度可降至亚纳米级别。
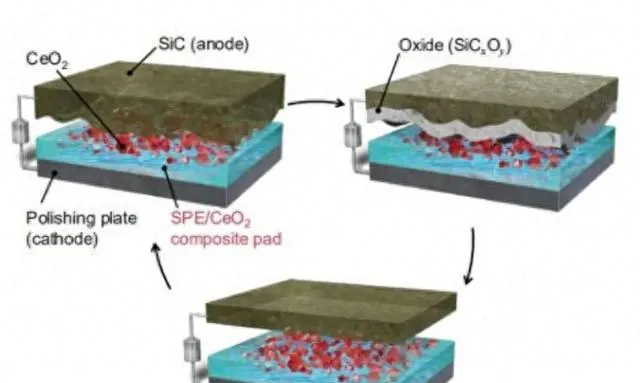
采用ECMP进行的材料去除工艺示意图
获取该文献,请加许若冰hangjiashuo999,详情请往下看:
技术原理
电化学机械抛光是一种新型的衬底表面处理技术,在ECMP过程中,碳化硅衬底作为阳极,与抛光板(阴极)之间夹着 SPE/CeO2复合材料衬垫 。当施加偏置电压时,碳化硅表面与SPE发生电解反应,形成一层易于去除的氧化膜,这层氧化膜随后被衬垫中的CeO2颗粒去除。

ECMP抛光装置的示意图
具体实验验证:
在实验过程中,研究团队首先研究了 电解电流密度 对碳化硅衬底材料去除率的影响,发现MRR与电解电流密度成正比,且在一定的电流密度下达到饱和:
● 在电解电流密度低于10 mA/cm²时,MRR随电流密度的增加而增加,法拉第效率 接近100% 。
● 超过15 mA/cm²后,MRR达到饱和状态,法拉第效率开始下降,表明电流密度的进一步提高并没有带来更高的材料去除效率。
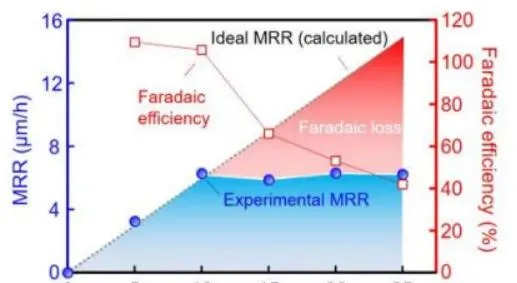
电解电流密度对ECMP的碳化硅(0001)的MRR和法拉第效率的影响
随后,他们进一步的实验探讨了 机械条件 ,即抛光压力和旋转速率的乘积(P×RR),对MRR的影响。实验在恒定的电解电流密度(25 mA/cm²)下进行:
● MRR随着机械条件的增强而线性增加,在最高的机械条件下几乎达到了法拉第电解定律预测的理想MRR值(14.8 µm/h)。
● 这一结果表明,在较高的机械条件下,CeO2颗粒更有效地去除氧化膜,减少了碳化硅表面形成的氧化物层的厚度,从而 提高了法拉第效率 。

ECMP的机械条件(MC)对碳化硅(0001)的MRR的影响
此外,研究团队利用X射线光电子能谱(XPS)分析了不同ECMP条件下处理的表面,结果显示在高机械条件下,经过ECMP和随后的无电解抛光,Si 2p光谱中没有明显的Si4+峰,表明表面残留的氧化物 被有效去除 。
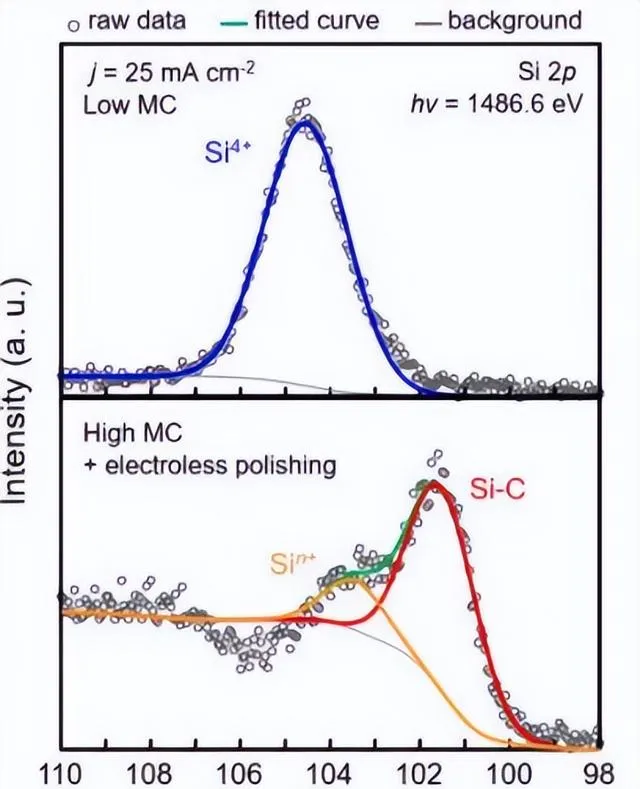
最后,研究团队进行了衬底表面形貌和粗糙度观察以及均匀性评估,结果如下:
● ECMP处理6分钟后,表面粗糙度从50 nm Sa显著降低到0.68 nm Sa,显示出 非常光滑 的表面。
● 在低电解电流密度下进行ECMP处理,然后进行无电解抛光,可以获得粗糙度为0.084 nm Sa的 超光滑表面 。

ECMP对碳化硅表面形态的改变(左)、经ECMP处理的碳化硅(0001)表面的AFM图像(右)
● 所开发的ECMP方法能有效地在整个晶片上均匀去除SiC表面,获得平均粗糙度低至 0.68 nm 的光滑表面。
实验验证表明,ECMP技术不仅提高了碳化硅衬底的抛光效率,而且通过精确控制电解和机械条件,实现了表面粗糙度的显著降低和表面质量的大幅提升,为碳化硅衬底的绿色制造提供了强有力的技术支持。
来源: 行家说三代半
*声明:本文由作者原创。文章内容系作者个人观点,宽禁带半导体技术创新联盟转载仅为了传达一种不同的观点,不代表本联盟对该观点赞同或支持,如果有任何异议,欢迎联系我们。











