摘要
透過采用CVD-SiC再生塊作為SiC源,成功生長了1.46 mm h的SiC晶體,生長速率高達1.46 mm h透過PVT方法。生長晶體的微管密度和位錯密度表明,盡管其生長速率高,但晶體質素良好。
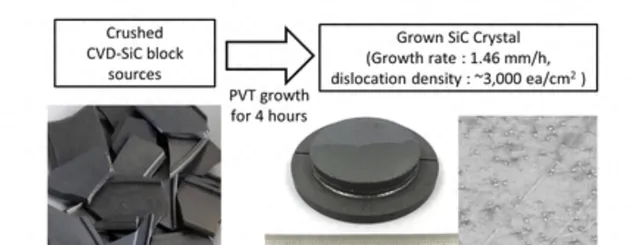
碳化矽(SiC)是一種寬禁帶半導體,具有優異的效能,可用於高電壓、高功率、高頻等套用,近年來其需求增長迅速,尤其是在功率半導體領域。對於功率半導體套用,SiC單晶是在2100–2500°C的高溫下使用高純度SiC源昇華生長的,然後透過物理氣相傳輸(PVT)方法在種子晶體上再結晶,然後加工以獲得晶圓上的單晶襯底。迄今為止,SiC晶體通常使用PVT方法以0.3至0.8 mm h的生長速率生長控制結晶度,結晶度比其他用於半導體套用的單晶材料相對較慢。當透過PVT方法以高生長速率生長SiC晶體時,到目前為止,尚未排除包括碳夾雜、純度下降、多晶生長、晶界形成以及位錯和孔隙缺陷在內的質素退化。因此,SiC的快速增長尚未得到發展,SiC的緩慢增長速度一直是阻礙SiC襯底生產率的一大障礙。

另一方面,最近報道的SiC的快速生長不是透過PVT方法,而是透過高溫化學氣相沈積(HTCVD)方法。HTCVD方法使用含有Si和C的氣相作為反應器中的SiC源。HTCVD尚未用於SiC的大規模生產,而是需要進一步的研究和開發才能從現在開始商業化。然而,非常有趣的是,即使在3 mm h的高生長速率下,SiC單晶也可以以良好的晶體質素生長透過HTCVD方法。
同時,SiC元件已被用於惡劣環境下的半導體工藝中,這些環境需要極高純度的過程控制。對於半導體工藝套用,純度為 99.9999% (6 N) 的 SiC 元件通常透過 CVD 工藝從甲基三氯矽烷 (Cp氯3Si, MTS)。然而,盡管CVD-SiC元件的純度很高,但到目前為止,它們在使用後已被丟棄。這就是為什麽廢棄的CVD-SiC元件最近被認為是SiC晶體生長的SiC源,盡管仍然需要一些回收過程,包括破碎和純化,以滿足作為晶體生長源的高要求。
在這項研究中,我們采用廢棄的CVD-SiC塊來回收材料作為生長SiC晶體的來源。用於單晶生長的CVD-SiC塊被制備為尺寸控制的破碎塊,與PVT工藝中常用的商業SiC粉末相比,其形狀和尺寸具有顯著差異,因此預計SiC單晶生長的行為將表現出顯著不同的行為。在進行SiC單晶生長實驗之前,進行了電腦模擬以獲得高生長率,並相應地配置了熱區以進行單晶生長。晶體生長後,透過橫截面斷層掃描、顯微拉曼光譜、高分辨率 X 射線繞射和同步輻射白光束 X 射線形貌對生長晶體進行評估。
圖1顯示了本研究中用於SiC晶體PVT生長的CVD-SiC源。如介紹中所述,CVD-SiC元件是透過CVD工藝從MTS合 成 的,並透過機械工藝為半導體使用而成型。N 在 CVD 工藝中摻雜,具有半導體工藝套用的導電性。在半導體工藝使用後,CVD-SiC元件被壓碎,以制備晶體生長的源,如圖1所示。CVD-SiC源制備為薄板,平均厚度為0.5 mm,平均粒徑為49.75 mm。

圖1 透過基於MTS的CVD工藝制備CVD-SiC源。
從圖1所示的CVD-SiC源中,透過PVT方法在感應加熱爐中生長了SiC晶體。為了評估熱區的溫度分布,使用了商業模擬程式碼VR-PVT (STR,塞爾維亞共和國)。具有熱區的反應器被建模為二維軸對稱模型,如圖2所示,其網格模型。仿真中使用的所有材料如圖 2 所示,其效能列在表 1 中。基於模擬結果,在2250–2350 °C的溫度範圍內,在Ar氣氛中,在35 Torr下,透過PVT方法生長了2英寸SiC晶體4 h。4°離軸4H-SiC晶圓用於SiC晶種。使用顯微拉曼光譜(Witec,UHTS 300,德國)和高分辨率XRD(HRXRD,X'Pert-PROMED,PANalytical,荷蘭)評估生長的晶體。使用動態二次離子質譜法(SIMS,Cameca IMS-6f,法國)評估生長的SiC晶體中雜質的濃度。在浦項光源處用同步輻射白光束X射線形貌法評估了生長晶體的位錯密度。
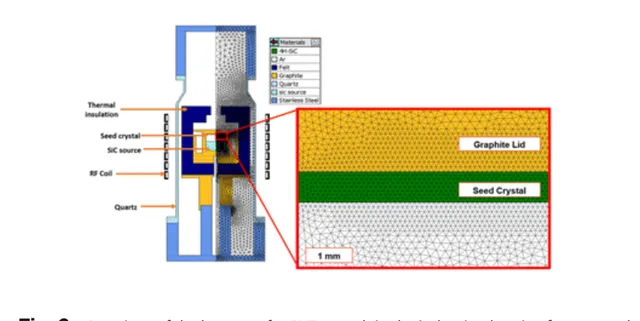
圖2 感應加熱爐中PVT生長的熱區圖及其網狀模型。

由於HTCVD方法和PVT方法在生長前沿的氣固相平衡狀態下生長晶體,因此透過HTCVD方法成功快速生長SiC導致了本文透過PVT 方法快速生長SiC的挑戰。HTCVD方法使用易於流量控制的氣源,而PVT方法使用不直接控制流量的固體源。當然,PVT方法中提供給生長前沿的流量可以透過控制溫度分布來控制固體源的昇華量,但是在實際生長系統中,PVT方法中溫度分布的精確控制並不容易實作。
透過提高PVT反應器中源的溫度,可以透過增加昇華源的流速來提高SiC的生長速率。要實作晶體的穩定生長,生長前沿的溫度控制就顯得尤為重要。為了在不形成多晶的情況下提高生長速率,需要在生長前沿實作高溫梯度,如透過HTCVD方法進行的SiC生長所示。沿垂直方向到蓋子背面的熱傳導不夠大,生長前沿積累的熱量應透過熱輻射散發到生長表面,導致形成多余的表面,即多晶生長。
PVT法的傳質和再結晶過程都與HTCVD法非常相似,盡管它們在SiC源上有所不同。這意味著,當SiC源的昇華率足夠高時,SiC的快速生長也是可以實作的。然而,到目前為止,透過PVT方法無法在高生長條件下實作高質素的SiC單晶有幾個原因。一般來說,商業粉末含有小顆粒和大顆粒的混合物,由於表面能的差異,小顆粒具有相對較高的雜質濃度,並且在大顆粒之前被昇華,這會導致生長初期生長的晶體中的雜質濃度很高。此外,由於固體SiC被分解成固體C和Si等蒸氣種類,SiC2和 Si2C在高溫下,當SiC源在PVT法中昇華時,不可避免地會形成固體C。如果形成的固體C足夠小和輕,那麽在快速生長條件下,小的C顆粒,即所謂的「C塵埃」,可以以很強的質素傳遞方式輸送到晶體表面,並在生長晶體中產生夾雜物。因此,為了減少金屬雜質和C塵埃,通常要求SiC源的粒徑直徑不超過200 μm,同時控制生長速率不高於0.4 mm h保持緩慢的質素傳輸,排除飛揚的C塵埃。金屬雜質和C塵埃會導致生長的SiC晶體降解,而SiC晶體是阻止PVT方法快速生長SiC的主要障礙。
本研究采用不含小顆粒的破碎CVD-SiC源,排除了強質素輸運下的飛C塵。因此,我們透過基於多物理場仿真的PVT方法設計了熱區結構,以實作SiC的快速生長,仿真的溫度分布和溫度梯度如圖3a所示。
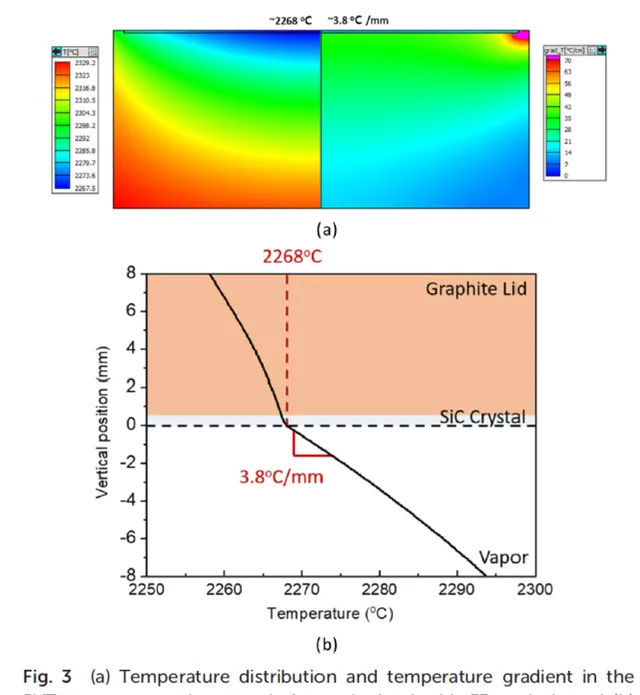
圖3 (a) 有限元分析得到的生長前沿附近PVT反應器的溫度分布和溫度梯度,以及(b)沿軸對稱線的垂直溫度分布。
與以 0.3 至 0.8 mm h 的生長速率生長 SiC 晶體的典型熱區設定相比在低於 1 °C mm 的小溫度梯度下,本研究中的熱區設定具有相對較大的溫度梯度,為3.8 °C mm生長溫度2268°C。該研究的溫度梯度值與透過HTCVD方法在2.4 mm h的生長速率下快速生長SiC的情況相當,其中溫度梯度設定為 14 °C mm.從圖3b所示的垂直溫度分布中,我們確認了在生長前沿附近沒有可能形成多晶的反向溫度梯度,如文獻中所述。
如圖 2 和圖 3 所示,在 PVT 系統中從 CVD-SiC 源生長 SiC 晶體 4 小時。從SiC生長的數量中,選擇了具有代表性的SiC晶體生長,如圖4a所示。圖4a所示的生長SiC晶體的厚度和生長速率分別為5.84 mm和1.46 mm h分別。研究了SiC源對圖4a所示生長的SiC晶體質素、多型、形貌和純度的影響,如圖4b-e所示。圖4b中的橫截面斷層掃描影像顯示,由於它們的生長條件沒有得到充分最佳化,因此晶體生長為凸形。然而,根據圖4c所示的微拉曼光譜,生長的晶體被鑒定為4H-SiC的單相,沒有任何多型夾雜物。透過X射線搖擺曲線分析得到的(0004)峰的半峰全寬(FWHM)值為18.9角秒,這也證實了良好的晶體質素。
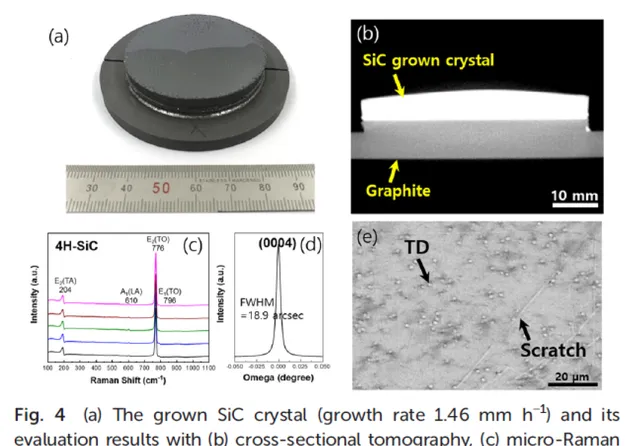
圖4 (a)生長的SiC晶體(生長速率1.46 mm h−1)及其與(b)橫截面斷層掃描、(c)顯微拉曼光譜、(d) X射線搖擺曲線和(e)X射線形貌的評估結果。
圖4e顯示了白色光束X射線形貌,可辨識生長晶體的拋光晶圓中的劃痕和螺紋位錯。生長晶體的位錯密度測量為 3000 ea cm−2,略高於晶種的位錯密度2000 ea cm−2.生長晶體被證實具有相對較小的位錯密度,這與商業晶圓的晶體質素相當。有趣的是,在大溫度梯度下,采用PVT方法以CVD-SiC粉碎塊為源,實作了SiC晶體的快速生長。生長晶體中 B、Al 和 N 的濃度為 2.18 × 1016, 7.61 × 1015和 1.98 × 1019原子每厘米3分別。生長晶體中P的濃度低於P的檢出限(<1.0×1014原子每厘米).作為電荷載流子的雜質濃度足夠低,但N除外,N是在CVD過程中有意摻雜的。
盡管考慮到商業化產品,本研究中的晶體生長是小規模的,但透過采用CVD-SiC源,成功地證明了透過PVT方法快速生長且晶體質素好的SiC具有有意義的意義。由於CVD-SiC源盡管效能優異,但透過回收廢棄材料而具有成本競爭力,我們預計其作為一種有前途的SiC源的廣泛利用將取代粉末形式的SiC源。為了將CVD-SiC源套用於SiC的快速生長,需要最佳化PVT系統的溫度分布,這為今後的研究提出了進一步的問題。
結論
在這項研究中,透過采用粉碎的CVD-SiC塊,成功地證明了PVT方法在高溫梯度條件下快速生長SiC晶體。 有趣的是,透過替換SiC源,PVT方法實作了SiC晶體的快速生長。該方法有望顯著提高SiC單晶制備的大規模生產率,最終降低SiC襯底的單位成本,提高高效能功率器件的普及率。
來源: 先進半導體材料
*聲明:本文由作者原創。文章內容系作者個人觀點,寬禁帶半導體技術創新聯盟轉載僅為了傳達一種不同的觀點,不代表本聯盟對該觀點贊同或支持,如果有任何異議,歡迎聯系我們。











