碳化矽(SiC)具有寬頻隙、高擊穿場強、高飽和電子漂移速率和高熱導率等優異效能,在新能源汽車、光伏和5G通訊等領域具有重要的套用。與目前套用廣泛的4H-SiC相比, 立方SiC(3C-SiC) 具有更高的載流子遷移率(2-4倍)、低的界面缺陷態密度(低1個數量級)和高的電子親和勢(3.7 eV)。利用3C-SiC制備場效應晶體管,可解決柵氧界面缺陷多導致的器件可靠性差等問題。但3C-SiC基晶體管進展緩慢,主要是缺乏單晶襯底。前期大量研究表明,3C-SiC在生長過程中很容易發生相變,已有的生長方法不能獲得單一晶型的晶體。
根據經典晶體生長理論,對於光滑界面晶體,同質二維形核需要克服臨界勢壘,存在臨界Gibbs自由能或過飽和度,而生長則可以在任意小的過飽和度下進行。對於異質形核,由於引入了新的固-固界面能,二維形核需克服更高的臨界勢壘。因此在相同過飽和度下,同質形核和生長在能量上明顯優於異質形核和生長,使得後者很難發生。
近期,中國科學院物理研究所/北京凝聚態物理國家研究中心的陳小龍團隊提出了 調控固-液界面能,在異質籽晶上較同質籽晶優先形核和生長的學術思想 。主要包括:1)3C(111)面和4H(0001)面的晶格失配度小,固-固界面能很低;2)4H和3C體相Gibbs自由能的差別較小;3)如果透過調控熔體成份,使得3C(111)-熔體的界面能較4H(0001)-熔體的界面能足夠低,二維形核以及後續生長的Gibbs自由能則對於3C相更有利。該團隊 自主設計、搭建了超高溫熔體表面張力和固-液接觸角測試器材 ,在高溫下測量了不同成份熔體的表面張力,熔體與4H-SiC、3C-SiC的接觸角,獲得了4H-SiC、3C-SiC與高溫熔體的固-液界面能的變化規律,驗證了界面能調控的可行性。該團隊 利用高溫液相法 ,實作了相同過飽和度條件下3C-SiC的Gibbs自由能更低的要求,抑制了生長過程中的相變, 在國際上首次生長 出 了 直徑2-4英寸、厚度4-10mm、單一晶型的3C-SiC單晶,如圖1和圖2所示。
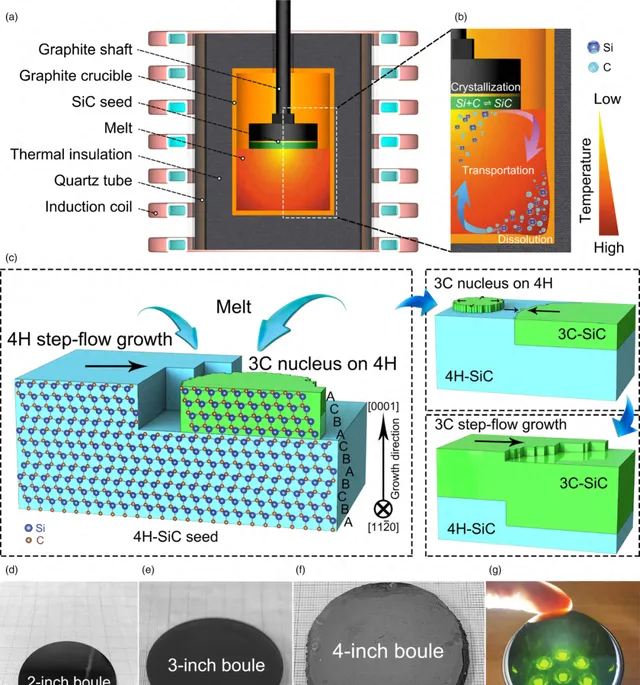
圖1. 采用高溫液相法,在六方碳化矽(4H-SiC)籽晶上實作了2-4英寸、厚度4-10 mm、立方碳化矽(3C-SiC)的異質形核和晶體穩定生長
沿晶體厚度方向的Raman散射光譜測量結果表明,生長一開始,3C-SiC即在4H-SiC籽晶上形核、生長,兩者共存區小於20 μm,見圖2(a-b),進一步證實了上述理論。(111)生長面的X射線搖擺曲線半高寬的平均值為30 arcsec,表明生長的3C-SiC具有高的結晶質素。3C-SiC單晶的室溫電阻率只有0.58 mΩ·cm,為商業化4H-SiC晶片電阻率(15-28 mΩ·cm)的~1/40,有望降低器件的能量損耗。

圖2. 3C-SiC晶型的確定。a) 在(111)生長面上隨機選取20個點的Raman散射光譜圖,插圖為測試點在晶體上的位置分布圖。b) 沿晶體厚度方向的Raman散射光譜圖。c) 300 K測量的光致發光(PL)圖譜。d) 高角環形暗場掃描透射電鏡(HAADF-STEM)圖。插圖為沿[11 0]晶帶軸的選區電子繞射(SAED)圖晶圓級3C-SiC單晶的生長填補了國內外空白,使3C-SiC晶體的量產成為可能,也為開發效能優異的電力電子器件提供了新的契機。同時,異質籽晶上較同質籽晶優先形核和生長的機制拓展了傳統的晶體生長理論。
相關成果以「High Quality and Wafer-Scale Cubic Silicon Carbide Single Crystals為題在Energy Environment Materials (2023, 0, e12678)上發表。博士研究生王國賓和盛達為共同第一作者,李輝副研究員和陳小龍研究員為共同通訊作者。王文軍主任工程師和郭建剛研究員深度參與了本工作。相關成果已申請了國內發明專利和國際PCT專利:陳小龍,李輝,王國賓,盛達,王文軍,郭建剛;用於制備3C-SiC單晶的方法;申請號:202310109001.9,PCT/CN2023/090284。以上工作得到了北京市科委、科技部、中國科學院、國家自然科學基金委、工信部等相關部門的大力支持。
編輯:悅悅











