失效分析 趙工 半導體工程師 2024年08月30日 08:19 北京
什麽是薄膜的保形性?
薄膜保形性,指的是薄膜沈積台階覆蓋力和空隙填附能力以及保留原始形狀的能力,即在所有三維結構上(頂部、側壁、底部)沈積的薄膜厚度相同,也稱共性覆蓋效果 (如圖1)。
ALD 薄膜保形性技術的提升,是改善TEM和SEM制樣及分析中品質的一大關鍵。
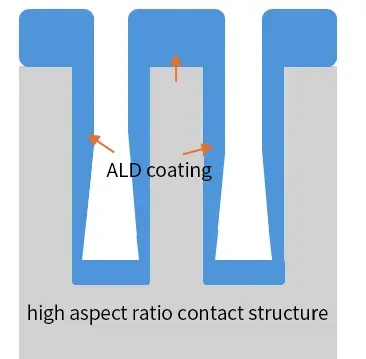
圖1 薄膜沈積台階覆蓋力
先進半導體制程鍍膜
和透射電鏡樣品制備的需求
透射電鏡樣品制備過程中,為改善部份樣品在電鏡中的對比度和清晰度,需要在樣品表面沈積一層薄膜,以達到更好的測試效果。這要求沈積過程中既要保證材料的均勻性,又要能夠精確控制材料的厚度和形狀。
隨著半導體產業的不斷發展,器件的尺寸逐漸減小,深寬比則不斷增加,則要求更先進的薄膜沈積技術,以達到更精確的效果。ALD技術由於其沈積參數可控(厚度、成分、結構),均勻性和保形性表現優異,在微納電子和納米材料等領域得到了廣泛的套用。
影響覆蓋能力和空隙填附能力的因素
ALD由於其自限性在所有薄膜沈積技術中已經是覆蓋性、致密度最好的技術,但其沈積過程仍然會受到復雜結構中的陰影效應以及材料在樣品表面遷移能力的影響,所以現今工藝在
Finfet
、3D NAND、TSV結構越來越復雜、孔隙越來越小越深,其陰影效應對側壁跟底部覆蓋能力的影響也越來越大。
主要影響覆蓋能力和空隙填附能力的因素如下:
1
溫度:
較高的沈積溫度有助於提高沈積物質在表面的遷移率,從而改善其沈積覆蓋能力;但溫度過高,會讓樣品的結構變形,導致各層薄膜的界面擴散反應和氧化等現象的發生,從而造成數據的錯誤。
2
飽和度:
要確認飽和度就必須確認其周期生長量(GPC);ALD的每個 周期迴圈 會歷經以下4個階段:
前驅體投料(Precursor Dosing)
清掃(Purge)
共反應物投料 /前驅體反應(Co-reactant exposure)
清掃(Purge)
由於其自限性,理想下每個周期的迴圈會沈積一樣的厚度,迴圈示意如圖 2:
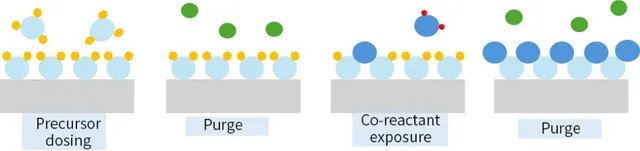
圖2ALD的周期迴圈
不斷提升ALD薄膜的保形性技術
改善TEM樣品分析技術
在理想情況下添加更多的Precursor-dosing或是Co-reactant以及延長Purge時間,並不會增加或減少其周期生長量(GPC);
在Precursor-dosing投料達到飽和情況下,借由調整其他時間來確認飽和度是否達到滿足,過短的共反應物配料時間會導致雜質摻入,而過短的吹掃時間會導致前驅體和共反應物分子在氣相或表面發生反應從而影響沈積薄膜的保形性和均勻性;
藉由了解上述的參數變化所產生的影響, 季豐電子對於ALD薄膜的保形性技術調整達到最佳化 , 如圖3(a)為調整前,圖3(b)為調整後。

圖3(a)前驅體投量時間不足
導致側壁底部共形效果差
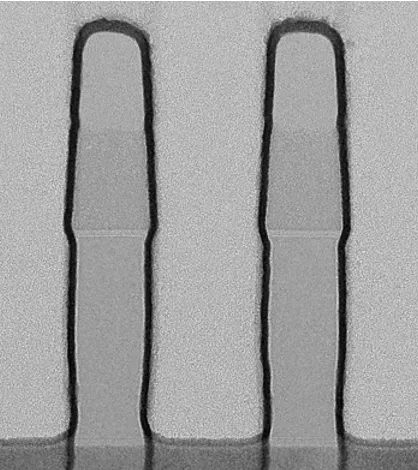
圖3(b) 調整前驅體的流量以及延長時間
得到大幅改善
季豐電子引入低溫 原子沈積系統 ALD-T200G,可以在38℃的低溫下進行穩定的沈積,同時保證優秀的step coverage,並精準控制薄膜厚度。
除常規樣品外,ALD-T200G還可以用於溫度敏感樣品的制樣前處理,能夠有效避免高溫帶來的界面擴散和氧化等問題,以提供更準確的測試結果,
來源:季豐電子

半導體工程師
半導體經驗分享,半導體成果交流,半導體資訊釋出。半導體行業動態,半導體從業者職業規劃,芯片工程師成長歷程。











