半個多世紀以來,半導體產業依循「摩爾定律」高歌猛進,但隨著集成電路先進制程工藝不斷微縮,距離物理極限越來越近,面臨技術瓶頸;另一方面,人工智能、5G、自動駕駛等新興產業蓬勃興起,對算力芯片效能要求逐漸攀升,迎來多重挑戰。
在此背景下,依托先進封裝 (AP,Advanced Packing),實作「More than Moore」(超越摩爾),已成為產業巨頭們角逐的關鍵所在。其中,2.5D先進封裝作為在半導體產品由二維向三維發展行程中的一大技術亮點,通常用於高端ASIC、FPGA、GPU和記憶體立方體,前景廣闊。
市場調研機構Yole預測,先進封裝市場在2021~2027年間復合增長率將達到9.81%,到2027年市場規模將達到591億美元;此外,2.5D/3D封裝技術將實作顯著增長,預計其復合增長率將達到13.73%,到2027年2.5D/3D封裝市場規模預計將達180億美元。
巨頭「逐鹿」先進封裝市場
先進封裝格局急劇變動,台積電、英特爾和三星等行業巨頭紛紛登場。
台積電作為領跑者,引領尖端先進封裝平台的開發——2020年,台積電宣布將其2.5D/3D封裝產品合並為一個全面的品牌「3DFabric」,由SoIC(系統整合芯片)、InFO(整合型扇出封裝技術)、CoWoS(基板上芯片封裝)所組成,進一步將制程工藝和封裝技術深度整合。
盡管先進封裝競爭激烈,巨頭之間各有所長,但在ChatGPT橫空出世,生成式AI紅遍全球的大背景下,台積電CoWoS備受追捧。7月18日,台積電發聲:「2025年CoWoS封裝產能將較2024年翻倍,CoWoS封裝產能在2025年將繼續保持緊張。」
據悉,CoWoS是一種2.5D的整合生產技術,由CoW、oS組合而來:將芯片透過Chip on Wafer(CoW)的封裝制程連線至矽晶圓,再把CoW芯片與基板(Substrate)連線,整合成CoWoS。該技術實作了提高系統效能、降低功耗、縮小封裝尺寸的目標,從而也使台積電在後續的封裝技術保持領先,為超越摩爾定律奠定了堅實基礎。
英特爾方面則推出EMIB、Foveros和Co-EMIB等先進封裝技術,力圖透過2.5D、3D和埋入式三種異構整合形式實作互連頻寬倍增與功耗減半的目標;三星電子緊追不舍,推出扇出型面板級封裝(FOPLP)技術,以取得更高性價比。
近十年來,封裝測試產業作為中國集成電路產業鏈中最具國際競爭力的環節,湧現了一大批優秀的封測企業。其中,天水華天科技股份有限公司(證券簡稱「華天科技」,證券程式碼:002185)作為全球前十的封測廠商,正持續提升核心業務技術含量,提高市場份額和盈利能力,技術水平及科研實力已處於國內同行業領先地位,向著先進封裝技術「攀高向新」!
華天科技打造eSinC 2.5D平台
公開資訊顯示,華天科技在擴大和提升現有集成電路封裝業務規模與水平的同時,大力發展SiP、FC、TSV、Fan-Out、WLP、2.5D、3D、Chiplet、FOPLP等先進封裝技術和產品。尤其是面向2.5D先進封裝賽道,華天科技致力打造eSinC(Embedded System in Chip)2.5D封裝技術平台,以此迎接人工智能(AI)時代高端封測需求。
公開資訊顯示,華天科技eSinC 2.5D封裝技術平台包含三大2.5D技術門類,分別是——矽轉接板芯粒系統SiCS(Silicon interposer Chiplet System)、扇出芯粒系統FoCS(Fan out Chiplet System)和橋聯芯粒系統BiCS(Bridge interconnection Chiplet System):
1.SiCS是采用矽轉接板實作多芯粒互連的2.5D先進封裝技術,這種結構通常具有高密度的I/O互連,適合高效能計算和大規模集成電路的需求,SiCS的優勢在於其精密的制造工藝和優越的電效能。
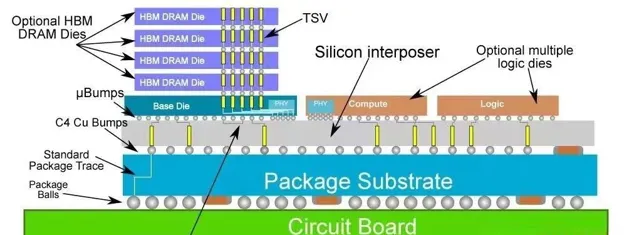
SiCS封裝結構示意圖
2.FoCS利用重新布線層(RDL)作為中介層來實作芯片之間的互連,主要用於降低成本並適應不同類別的器件連線需求,具有更大的設計靈活性,能夠支持更多的芯片連線FoCS 技術的關鍵特點包括:使用RDL中介層,由聚合物和銅線組成,具有相對較高的機械靈活性。
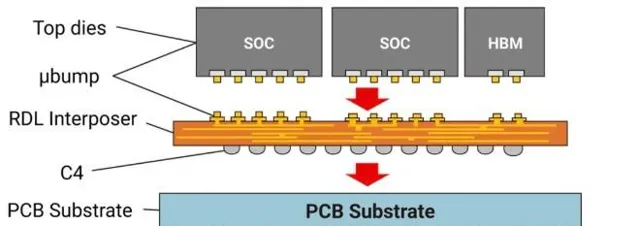
FoCS封裝結構示意圖
3.BiCS關鍵特性包括:使用LSI芯片實作高密度的芯片間互連,這些芯片可以具有多種連線架構,並且可以重復用於多個產品,基於模具的中介層較寬的RDL層間距,並采用穿透中介層的通孔來實作訊號和電力的低損耗高速傳輸,能夠整合額外的元件。
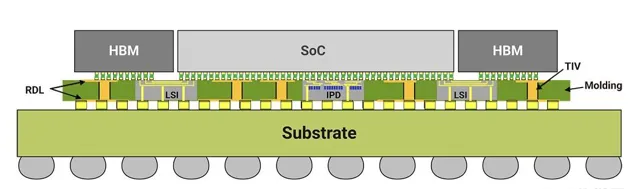
BiCS封裝結構示意圖
值得一提的是,當前火爆的台積電CoWoS封裝技術主要分為「S、R、L」三大類別,而華天科技eSinC 2.5D封裝技術平台中的SiCS、FoCS則分別對標CoWoS的「S、R」兩大技術分類,效能優異。
AI助推先進封裝市況
先進封裝市況大好,產業巨頭紛紛擴張——台積電在多地擠出廠房空間增充CoWoS產能,甚至為應對溢位的先進封裝產能,還委外給日月光承接相關訂單;英特爾副總裁兼亞太區總經理Steven Long則表示,該公司正在馬來西亞檳城興建最新的封裝廠,強化2.5D/3D封裝布局;安靠(Amkor)在去年12月宣布斥資20億美元在美國亞利桑那州建造先進封裝廠。
華天科技也不例外。目前,華天科技在全球總計擁有9座工廠,分別是天水、西安、江蘇、南京、昆山、上海、韶關、成都、馬來西亞,面向不同領域布局先進技術。2024年,華天科技堅持以市場為導向的技術創新,持續進行先進封裝技術和產品的研發以及量產工作,加快 2.5D、FOPLP 封測量產能力建設:
3月28日,華天科技南京公司成立南京工廠二期專案,總投資100億元,擬新建20萬平方米的廠房及配套設施,新增工藝器材5000台/套,打造先進封測基地,產品將主要套用於儲存、射頻、算力(AI)、自動駕駛等。華天科技透露:「在南京按照fab標準布局2.5D專用廠房,器材將在今年下半年陸續到廠,年底完成偵錯,給客戶提供打樣服務。」

6月30日,江蘇盤古半導體科技股份有限公司多芯片高密度板級扇出型封裝產業化專案奠基儀式舉行。這是華天科技2018年落戶以來,在南京布局的第四個重量級產業專案,將聚焦板級封裝技術的開發及套用,建設世界首條全自動板級封裝生產線。
中信證券研究訊息稱,隨著下遊需求逐步回升,半導體行業增速回到2021年周期啟動前水平,傳統封裝有望進入復蘇通道;此外,先進封裝在AI時代增量需求及國產替代空間巨大。
華天科技7月13日公布的【2024年半年度業績預告】也印證了上述觀點:上半年盈利1.9億-2.3億元,凈利潤同比預增202.17%—265.78%。公告表示,報告期內,公司訂單增加,產能利用率提高,營業收入較去年同期有顯著增長,從而使得公司經營業績大幅提高。











