在最近发布的【首台(套)重大技术装备推广应用指导目录(2024年版)】中,工信部明确提出了我国光刻机技术的新里程碑。文件特别提到了集成电路制造领域的最新进展,包括氟化氪光刻机和氟化氩光刻机两大类。
这次更新强调了氟化氪(KrF)和氟化氩(ArF)光刻机的应用,这两种设备都采用了深紫外(DUV)技术。氟化氩光刻机尤其引人注目,其核心技术指标包括:193nm的光源波长、最小可达65nm的分辨率以及不超过8nm的套刻精度。

这些技术参数的具体含义如下:
193nm光源
目前光刻技术已经发展至第五代。简要概述如下:

第一代:G线光刻机,光源波长为436nm,主要适用于生产350nm及以上规格的芯片。
第二代:I线光刻机,光源波长为365nm,专为350nm芯片制造设计。
第三代:氟化氪(KrF)光刻机,光源波长248nm,能够生产130nm规格的芯片。
第四代:氟化氩(ArF)光刻机,其光源波长为193nm,基础产能覆盖至65nm芯片。采用浸润式技术后,有效波长可减至134nm,支持7nm及更精细芯片的生产。
第五代:EUV光刻机,专为7nm以下芯片制造设计,目前市场上如台积电、三星等采用的均为ASML的EUV光刻机。
193nm的波长属于深紫外区域,这标志着我国的光刻机技术已站在第四代的门槛上。
65nm分辨率

光刻机的分辨率反映了其在硅片上清晰投影并区分邻近图形的能力。
分辨率计算可通过公式 分辨率 = k 1 × λ N A \text{分辨率} = k1 \times \frac{\lambda}{NA} 分辨率 = k 1 × N A λ 得出,其中 k 1 k1 k 1 是常数, λ \lambda λ 是光源波长, N A NA N A 是物镜的数值孔径。提高物镜的数值孔径是提升分辨率、制造更精密芯片的关键。
以ASML为例,其DUV光刻机的NA已从0.4提升至0.93,而EUV光刻机更是从0.33增至0.55,这些升级显著提高了芯片的制造精度。
就当前情况而言,虽然ASML的DUV光刻机分辨率已达到34nm,但国产光刻机已达到65nm的分辨率,这显示了国产技术在追赶国际前沿的过程中取得的重要进展。

多重曝光实际上是一种复合曝光技术,它在不变更光源波长的前提下提升了分辨率,从而生产出更高级的芯片。
举个例子,台积电使用1980Di型、波长为134nm的光刻机为华为生产了7nm工艺的麒麟990芯片,这正是运用了多重曝光技术的成果。

目前,常见的多重曝光技术包括曝光-固化-曝光-刻蚀(LFLE)、双重曝光(LELE)、三重曝光(LELELE)和自对准多重图形(SAMP)等技术。
双重曝光技术能显著提高28nm芯片的图像质量,使其相当于14nm。
而三重曝光和自对准多重图形技术则更多应用于16nm、14nm以及7nm工艺。
在多重曝光过程中,套刻的精度尤为关键。
每次曝光的位置必须非常精确地对齐,否则就会导致电路结构错误,因此两次曝光的位置偏移是衡量套刻精度的重要标准。
此外,多重曝光还意味着成本增加,同时还会影响光刻机的生产效率、良品率和耗电量,从而导致更高的成本。
理论上,≤8nm的套刻精度能够制造出8nm芯片,但实际生产中可能因为成本和良品率问题而放弃生产。例如,如果一批8nm手机芯片的单颗成本高达1500元,并且发热严重,其实际意义将大打折扣。
而且,国产光刻机的分辨率目前为65nm,与蔡司的物镜还存在一定差距。
因此,使用浸润式技术的国产ArF光刻机目前应该能够制造出14nm芯片,这已经是一个相当大的突破。
目前,14nm及以上工艺的芯片在航天军工、汽车、工业和家电等多个领域的应用非常广泛,市场份额高达70%。而7nm及以下的高级芯片则主要应用于智能手机、高级CPU、超级计算、AI芯片和自动驾驶领域,市场份额约为30%。

因此,国产氟化氩(ArF)光刻机的问世,预计将大幅提高我国芯片产业的自给率至70%,并有望在2-3年内实现7nm芯片的国产化。
在全球范围内,能够独立研发光刻机的国家仅有荷兰、日本和中国。

荷兰的ASML是光刻机技术的领导者,其产品集成了全球技术,如美国的光源、德国的物镜、法国的轴承,并且还使用了来自日本和中国台湾的部分技术。据悉,ASML的供应商多达3000家,遍布全球。
日本尼康虽然技术水平紧随ASML之后,但也无法完全自主,受到欧美技术的制约。

唯一的中国则完全依靠自主研发,因为在光刻机方面,包括零部件的出口对中国是禁止的。这足以证明关键核心技术已实现100%的国产化,这是其他国家所不具备的。
但我们也应看到,光刻机技术的道路依然充满挑战。下一代的EUV光刻机要求更高,对光源技术、物镜系统以及双工作台、轴承、线缆等方面的要求都更为苛刻。
需要使用13.5nm的极紫外光源技术、比浴室镜面还要平整100倍的物镜和纳米级误差的双工作台等,这些听起来就令人感到窒息。
一旦这些技术突破,全球芯片产业格局将彻底被颠覆,ASML的领先地位也将不保。
从早期ASML的工程师嘲笑中国「即便公开图纸,他们也造不出来」,到后来的「中国无法造出先进光刻机」,再到去年ASML总裁温宁克称「中国自主研发光刻机破坏了全球产业链」,ASML的态度已经暗示了中国光刻机的迅速发展。
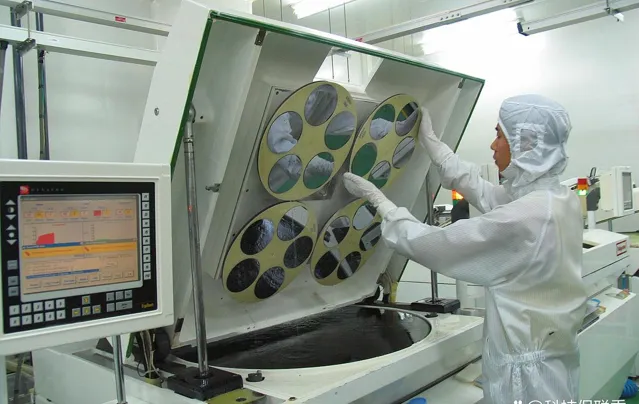
中国在光刻机自主研发的道路上已进入深水区,只要坚持脚踏实地、一步步前进,未来的EUV光刻机必将实现突破,从而逆袭超越成为可能。











