掃描電鏡與透射電鏡的區別:掃描電鏡(SEM)和透射電鏡(TEM)是兩種常用的電子顯微鏡,它們在觀察樣品的表面和內部結構方面各有特點。以下是對這兩種顯微鏡的詳細比較:
一、成像原理
1. 掃描電鏡(SEM): SEM主要透過電子束與樣品表面交互作用產生的訊號來成像。當高能電子束轟擊樣品表面時,會產生二次電子、背散射電子、特征X射線等訊號。這些訊號被探測器收集並轉換成影像,從而展示樣品的表面形貌和成分。
2. 透射電鏡(TEM): TEM利用電子束穿過樣品,透過樣品內部結構對電子束的繞射和散射來成像。電子束的波長比可見光短得多,因此TEM具有更高的分辨能力。TEM成像依賴於樣品內部的電子密度差異,能夠觀察到樣品的內部結構。

二、結構組成
1. 掃描電鏡(SEM)
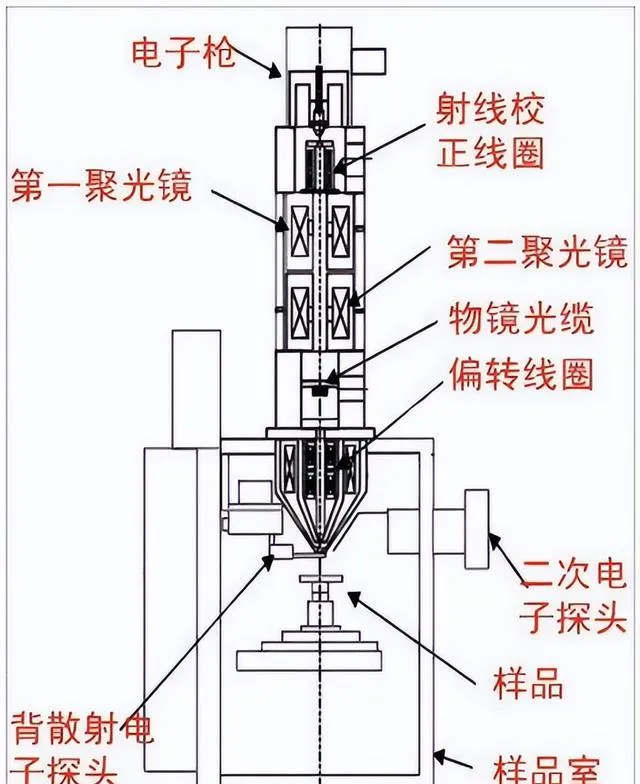
鏡筒: 包括電子槍、聚光鏡、物鏡及掃描系統,用於產生並控制電子束在樣品表面的掃描。
電子訊號的收集與處理系統: 收集樣品表面激發的各種訊號,如二次電子、背散射電子等。
電子訊號的顯示與記錄系統: 將訊號轉換為影像,顯示在陰極射線管上,並可透過照相機記錄。
真空系統及電源系統: 確保鏡筒內達到高真空度,提供穩定的電源。
2. 透射電鏡(TEM)

電子光學部份: 包括電子槍、聚光鏡、樣品室、物鏡、中間鏡、投影鏡等,用於控制電子束的路徑和成像。
真空系統: 排除鏡筒內瓦斯,確保高真空度。
供電控制系統: 穩定提供加速電壓和透鏡磁電流,保證成像品質。
三、功能對比
1. 掃描電鏡(SEM)
形貌分析: 透過二次電子探測器獲取樣品表面的形貌影像。
化學成分分析: 利用X射線能譜儀或波譜分析樣品的化學成分。
晶體結構分析: 透過背散射電子繞射訊號分析樣品的晶體結構。
特殊套用: 在半導體器件研究中,SEM可用於積體電路的pn接面定位和損傷研究。
2. 透射電鏡(TEM)
形貌觀察: 觀察樣品內部的組織形貌。
晶體結構分析: 利用電子繞射對樣品晶體結構進行原位分析。
成分分析: 透過能譜儀(EDS)和特征能量損失譜(EELS)進行原位的成分分析。
動態觀察: 結合高溫台、低溫台和拉伸台,觀察樣品在不同狀態下的動態組織結構。
四、襯度原理
1.掃描電鏡(SEM)
質厚襯度: 由樣品不同微區的原子序數和厚度差異形成。
繞射襯度: 由晶體試樣各部份滿足布拉格反射條件不同和結構振幅的差異形成。
2. 透射電鏡(TEM)
品質厚度襯度: 由樣品不同微區間的原子序數或厚度差異形成。
五、樣品要求
1. 掃描電鏡(SEM): 樣品厚度無嚴格要求,可透過切、磨、拋光等方法制備表面。
2. 透射電鏡(TEM): 樣品需要非常薄,通常只有10~100nm厚,以確保電子束能穿過樣品。
透過以上比較,可以看出掃描電鏡和透射電鏡在成像原理、結構組成、功能、襯度原理和樣品要求等方面都有顯著區別。每種顯微鏡都有其獨特的套用領域和優勢,選擇合適的顯微鏡對於進行有效的材料分析至關重要。











